2.5D Chiplet和3D-IC是后摩尔定律时代广受关注的突破性技术,全球工业界和学术界都对相关技术的研发和产业化进程投注了极大热情。
青芯半导体科技自2020年以来,与工业界伙伴们密切合作,共同实现了数款3D-IC的设计和流片工作,且均已实现大规模量产。在2.5D Chiplet领域,青芯半导体也正携手业界领先的晶圆代工厂和封装厂,构建设计平台,加速工业界在Chiplet异质集成的产品开发进度。这些前瞻性的技术工作和丰硕的成果,受到了行业同仁的广泛认可与高度赞誉。
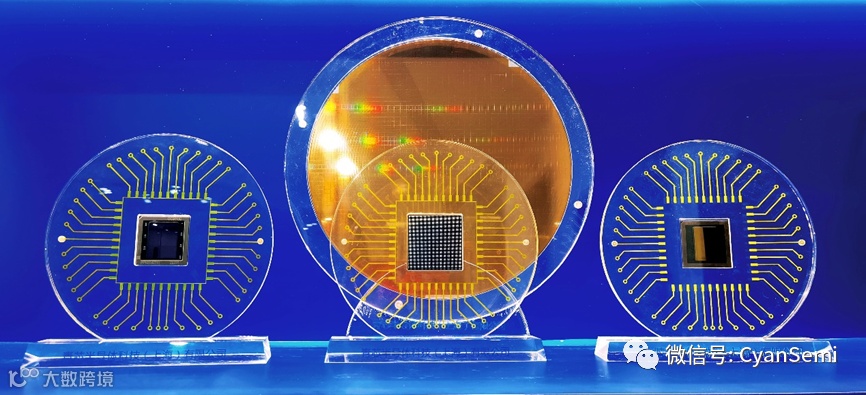
图源:青芯公司成功流片的部分芯片
2022年7月30日受首届中国计算机学会芯片大会组委会的邀请,张哲明博士代表青芯半导体科技出席本次大会Chiplet与三维集成电路设计分论坛,针对《封装对于芯片设计的影响》这一主题进行了专题报告。
有关首届CCF芯片大会

图源:半导体行业观察
2022年7月29日,首届中国计算机学会芯片大会(CCF Chip Conference,以下简称:CCF Chip)在南京国际博览中心开幕。本届CCF Chip以“构建芯生态,链接芯未来”为主题,邀请了计算机、微电子和电子信息等领域内的中科院院士及相关企业高管代表出席,共设34个分论坛,覆盖了集成电路行业的方方面面,其中以30日下午Chiplet与三维集成电路设计分论坛最受欢迎(获得孙凝晖院士与刘明院士签名奖状“最受欢迎论坛”)。本领域内的学术界和企业界知名专家对Chiplet和三维集成电路中的科学问题和关键技术展开了热烈的讨论。作为该论坛内唯一受邀的来自工业界的专家,我公司芯片封装与供应链负责人张哲明博士,在论坛演讲中发表了相关报告,阐述了芯片封装在Chiplet设计领域中的重要影响。

图源:半导体行业观察
Chiplet通常是指在一个封装中使用多颗独立制造的小芯片在晶圆级实现互连的技术。在摩尔定律到达极限的今天,Chiplet被行业普遍认为是集成电路制造的技术选择。由于中国大陆的半导体制造业在先进芯片制程方面相对落后,所以利用新型封装技术集成和互连国内积累多年的处理器、存储器等Chiplet,可以实现对标或超过国外高端芯片算力目标,也是我国突破半导体工艺被卡脖子的重要途径。
相对传统的芯片封装,Chiplet芯片往往尺寸较大且功耗集中,因此传统的封装技术也遇到了新的挑战。张哲明博士指出,芯片的设计与封装不是简单的上下游关系,在设计早期就需要进行系统性的整体考虑,芯片设计、封装设计与系统设计三者之间相互作用,相辅相成。然而在实践中,很多芯片设计公司常常忽略了后续封装的可设计性与可制造性,就会导致芯片设计虽然完善,但难以封装生产的问题。因此,芯片设计者在设计初期就需要考虑封装设计与系统设计,只有深刻地理解封装设计与系统设计这两个环节的需求和痛点,才能设计出更符合实际需求的芯片,最终才能实现高生产良率和高生产稳定性。
此外,张哲明博士还针对大尺寸高功耗芯片封装设计中的技术要点进行了分析,并结合实际案例进行了分析。
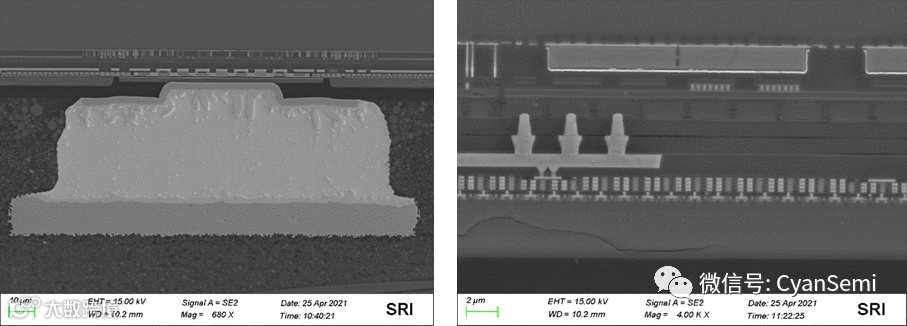
图源:3DIC芯片的扫描电镜图 - 2022 CCF芯片大会张哲明主题演讲报告
首先需要考虑的是基板设计。目前采用Chiplet和3D封装技术的芯片的基板选择以ABF类为主,原因在于ABF类基板能够支持更小的bump pitch(硅片上凸点间距)和更小的线宽线距。这样的优点使得ABF类基板迅速变成了稀缺资源并产生了新的供应链问题。在基板的设计阶段,除了传统的SI、PI仿真需要满足要求外,还要尽可能满足传统BT基板的设计准则,降低封装对于ABF基板供应链的依赖。
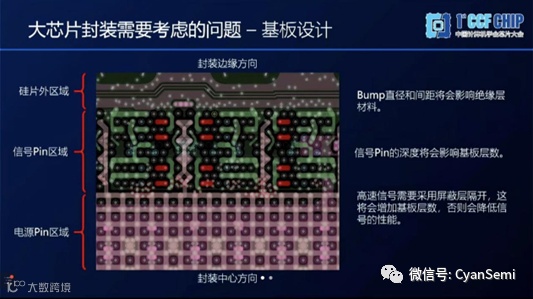
图源:2022 CCF芯片大会张哲明主题演讲报告
其次需要考虑的是基于系统的封装散热仿真。Chiplet类芯片往往功率密度较大,在使用过程中会产生大量的热量。因此在封装设计环节就需要将芯片、封装、系统三者统筹考虑,建立整体的热仿真模型。在芯片生产前,就发现并解决芯片在使用过程中因散热能力不足而导致的潜在风险,避免芯片出现局部热点进而导致过热失效的情况发生。

图源:2022 CCF芯片大会张哲明主题演讲报告
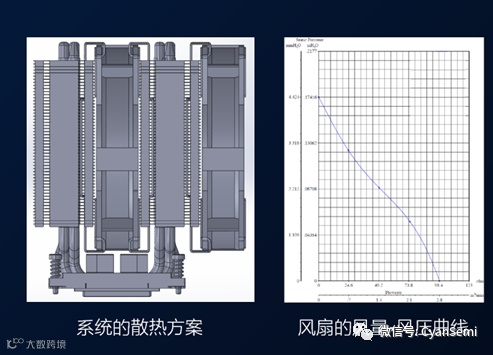

图源:2022 CCF芯片大会张哲明主题演讲报告
最后,还需要考虑封装生产时的问题。芯片封装包括各种热膨胀系数差异较大的材料,而封装过程中又会经历多次回流焊、高温固化等需要加热-降温的环节。这些就导致芯片发生较大的形变与内应力,进而降低芯片在封装生产过程中的良率,同时也将导致芯片在使用过程中失效率增高。张哲明博士还提出翘曲是芯片封装生产中不可忽视的重要问题。除了高温时不同的封装材料的热膨胀系数不同外,芯片的硅片尺寸和基板尺寸也是重要的影响因素。一般来说芯片尺寸越大,其边缘的翘曲将会越严重,进而导致芯片在贴片中容易出现虚焊,在使用中容易出现裂纹。这类问题在基于晶圆级封装技术的2.5D封装中将尤为明显。
关于青芯半导体科技
青芯半导体科技(上海)有限公司是一家集成电路设计企业,专注于高性能异构加速领域的芯片和IP设计工作,公司围绕服务器加速领域(计算加速,互联加速,存储加速和安全加速)展开自有芯片产品开发和客户定制芯片产品开发。作为一家深耕全球高端定制芯片市场的公司,青芯拥有端到端的多样化研发技能,以及先进工艺下超大规模、超高复杂度的“巨型芯片”设计能力,所有芯片产品均一次流片成功,并有数个产品已开始量产。
青芯作为业内为数不多的3DIC和2.5D Chiplet解决方案供应商,在相关芯片设计方向有着深厚的技术积累,处于行业领先地位。凭借多款3D-IC芯片的研发和量产经验,青芯的研发团队开发的多工艺堆叠芯片整合的功耗、仿真时序验证和物理验证的流程为行业提供了技术先例。在过去18个月内,青芯完成了三款采用3D设计的超大规模芯片,并已获取了多项应用于3D芯片设计领域的专利、EDA软件著作权。


