 图为主持人梁钊先生
图为主持人梁钊先生
金浦智能总裁田华峰博士在致辞中表示,在新的国际格局下,硬科技发展迫在眉睫,也是金浦智能团队的重点关注方向。硬科技领域国产替代以及供应链安全问题被高度重视,半导体是科技创新的基础也是新质生产力的重中之重。随着人工智能日新月异的高速发展,对日常生活、工业生产乃至整个社会都带来了深远的影响,进而推动集成电路以及上下游相关产业的发展。先进封装在一定层面上是有助于提升半导体产业竞争力的重要领域,也是中国产业界有机会发力的赛道。希望通过本次行业研讨会与参与嘉宾共同探讨先进封装领域的发展趋势和投资机会。
 图为田华峰博士致辞
图为田华峰博士致辞
随后,研讨会正式进入了嘉宾主题分享环节。第一位分享嘉宾是广发证券资深分析师焦鼎博士。焦博士是中国科学院博士,拥有3年证券研究经验,覆盖半导体设备、材料和封测行业。焦博士注重深度研究,跟踪技术发展趋势,构建完善的产业分析框架,积极挖掘产业链标的新机遇。
 图为焦鼎博士正在进行主题分享
图为焦鼎博士正在进行主题分享
焦鼎博士分享的主题是“COWOS & HBM持续迭代,先进封装助力产业升级”。焦博指出,先进封装技术升级的核心是提升互连密度以提高数据传输速率。SoC中的片上互连拥有最高的互连密度,远高于传统倒装封装。目前,2.5D CoWoS封装显著提升了互连密度。3D封装技术通过堆叠芯片将键合通道间距缩小到几微米以内,可以实现和片上互连相当的互连密度。目前先进封装中硅中介层和HBM的制造涉及多种前道晶圆制造技术,如光刻、TSV刻蚀、薄膜沉积、晶圆减薄、化学机械抛光等。先进封装市场的增长有望带动相关设备市场持续成长。此外,键合工艺直接决定了垂直互连的密度,是先进封装中的核心工艺。混合键合技术可以实现铜对铜直接互连,能够将互连间距微缩至10微米以下,有望成为未来芯片垂直堆叠的主要键合技术。


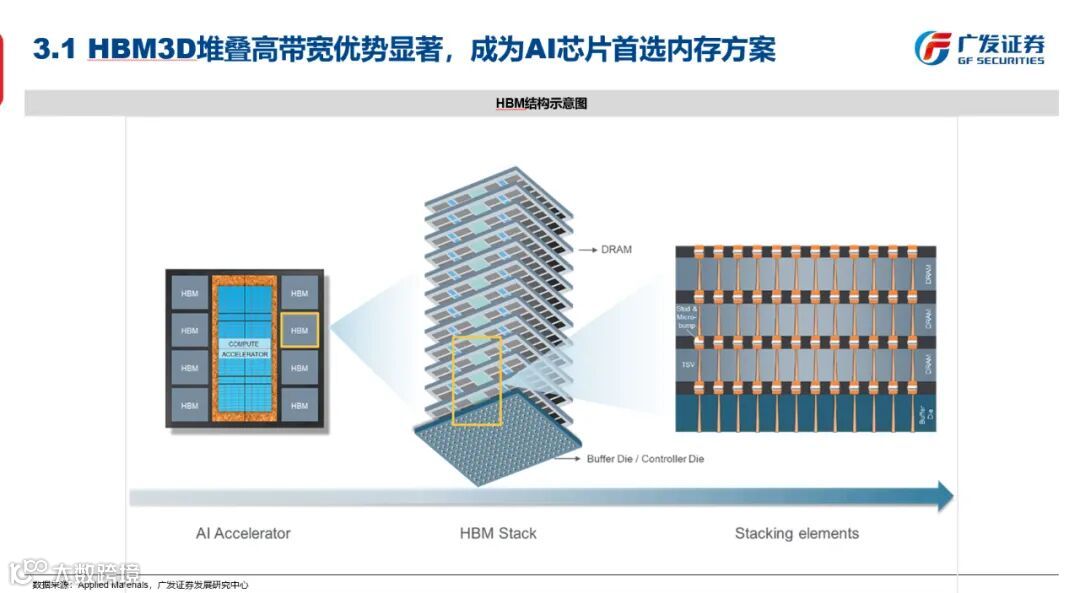
第二位分享嘉宾为先进封装行业专家华克路。华总分享的主题是“先进封装的市场机会和技术挑战”。华总指出虽然单个晶体管的制造成本持续下降,但数量仍遵照摩尔定律指数级增长,当单一晶体管成本无法下降时整体成本将不断上升。因此,从技术迭代的角度来看,性能、功耗、面积、制作成本是综合考量因素,先进封装将多种工艺集成一体要比单一工艺封装设计更为有效。相较CoWoS,英特尔的EMIB嵌入式硅桥技术更适合中国消费电子级边缘计算的应用场景,技术更为简单,制作成本仅为CoWoS的1/3,或许在国内更具发展前景。目前国内封测厂业务布局多集中于bumping和WLCSP技术,2.5D和3D技术的开展较为早期,仅有长电和盛合晶微有实际业务。当下先进封装面临的最主要问题是TSV的技术问题,现在市面上普遍深宽比为5倍,技术好的能做到10倍,应用材料的目标是做到20倍,孔径越小时硅片面积利用率越高。技术的核心难点在于刻蚀采用的为各向腐蚀而非单向腐蚀,需要在向下腐蚀的过程中持续注入气体,同时将做好的部分用氧化硅封好,整个流程涉及到两套工序和设备,因此TSV极高的工艺难度及制作成本一定程度上限制了技术的发展。
 图为华总正在进行主题分享
图为华总正在进行主题分享
嘉宾提问环节中,从凸块材料的角度来看,华总认为在下一步更为精细化的需求场景下可能会形成一个新的合金材料,但就目前的尺寸而言铜确实为最佳的选择,唯一的缺点是会扩展并污染器件,需要用到氮化钛保护层。关于玻璃基板的应用,华总表示其在使用效率上有很大优势,且热稳定性很好。目前有两种途径可以将玻璃改性以更轻易地实现TGV,一种是用激光破坏氧化硅结构使得氟化氢的腐蚀更容易,或是在玻璃中掺杂以破坏氧化硅稳定的六方结构。玻璃基板当下面临的主要发展瓶颈是设备及经验的问题,研发阶段需要较大的资金投入。其次,华总指出相较前道设备,先进封装所用设备的和核心难点为在10-7-10-10大气负压环境下封装材料会被抽出粒子和水分形成污染,需要被针对性地解决掉。



第三位分享嘉宾是矽赫微科技(上海)有限公司创始人、董事长王笑寒博士。王博士毕业于美国密歇根州安娜堡密歇根大学,2023 年创立键合设备公司矽赫微科技(上海)有限公司并担任公司董事长,曾任睿励科学仪器 CTO、KLA Tencor,Milpitas,CA,USA项目经理,从事半导体级光学和电子束缺陷检测设备研制。
 图为王笑寒博士正在进行主题分享
图为王笑寒博士正在进行主题分享
王笑寒博士分享的主题是“半导体键合设备在先进封装中的应用”。王博士指出,键合技术在半导体领域中的应用广泛,而混合键合技术越来越多的应用在先进封装领域。键合技术最早起源于80年代末90年代初,半导体混合键合技术早期应用于AMD,预计HBM4之后会更多应用混合键合技术。混合键合是指同时完成介质间的直接熔融键合和金属间的扩散键合,使得两个分开的芯片或晶圆结合成一个整体。晶圆对晶圆的键合是将两片晶圆进行结合,芯片对晶圆的键合则有两种方式,一种是将芯片临时键合到一片晶圆上再将其倒置与另一片晶圆键合,其中包含了一次解键合;另一种方式是将芯片通过高精度对准直接键合到晶圆上。王博士提到,相对于Micro Bonding,混合键合可以降低互联的信号损失,同时极大程度上提高互联密度。设备方面,实现混合键合需要通过等离子体激活、水洗、高精度对准、预键合、检测、退火六个步骤。芯片对晶圆键合设备是前道设备技术和后道设备技术的集成,为了完成该技术,市面上多为两个厂商合作研发的形式,典型的案例有Besi与台积电的合作研发实现了D2W键合设备的开发。王博士指出,去年全球混合键合设备市场规模为8.9亿美元,预计到2030年增长到15亿美元左右。混合键合使得晶圆与晶圆或芯片与晶圆间绝缘部分与信号连线部分直接键合在一起,从而使分开制造的芯片部分直接合成一个系统,在先进封装中有广泛的应用并在持续发展。
第四位嘉宾为上海道宜半导体材料有限公司研发总监陆海平先生,毕业于南京理工大学化学工艺专业。上海道宜半导体材料有限公司成立于2020年05月,是一家致力于IC封装用的环氧塑封料(EMC)的研发和生产的企业。陆总大学毕业后,曾先后从事IC封装及EMC研发工作,在半导体关联领域有20多年的工作经验。 为应对客户不同的产品对EMC的需求,对材料韧性、接合力、流变性、低应力等特性进行针对性改良。伴随着IC封装技术的发展,开发能适配MUF、高导热、指纹识别、Compression Mold 等先进封装应用的EMC产品。
 图为陆总正在进行主题分享
图为陆总正在进行主题分享
陆总分享的主题为“先进半导体封装及未来趋势”。陆总表示IC性能的提升主要通过精进晶圆生产工艺、提高封装集成度(大芯片、多芯片、高I/O密度)以及采用碳化硅、氮化镓晶圆材料三大方式。先进封装市场发展的核心推动因素主要有生成式AI需求的高涨,因中美贸易战引起的,我国出口至欧洲的电动汽车关税上升,导致部分车企不得不到海外新建工厂,所带来的当地基建项目需求,以及受到自动驾驶所需的算力芯片和存诸芯片的需求增长的影响。从材料端来看,CoWoS封装工艺具体应用到的材料主要有液态环氧塑封料(LMC)、非导电薄膜(NCF)、散热胶(TIM),工艺流程中塑封材料被多次使用,以起到芯片表面隔离保护和焊球保护的作用。据日本调研机构数据,材料端增速第一的为放热材料,包含氧化铝、导热膜和ABM基板等;第二增速的为基板材料,如铜箔、积层板等。目前业界主流工艺采用Transfer Mold的方法进行塑封,更为先进的封装工艺需采用Compression Mold的方法,例如晶圆级封装、板级封装和BGA工艺等。Compression Mold采用的塑封料主要分为三种形式,分别有各自的应用领域。其中,液态材料(LMC)填充能力最好,固态材料价格便宜但性能局限性较强(EMC),Sheet压缩工艺则适用于薄形大尺寸的产品。



在随后的先进封装圆桌论坛上,由广发证券资深分析师焦鼎博士担任主持人,并邀请矽赫微科技(上海)有限公司创始人及董事长王笑寒博士、德沪涂膜设备有限公司创始人及董事长兼总经理王锦山博士、甬矽电子董事会秘书李大林、浙江禾芯集成电路有限公司董事长张黎、道宜半导体研发总监陆海平就先进封装技术的发展趋势、产业现状以及国产化进程进行了深入探讨和交流。

对于如何看待先进封装特别是cowos等先进技术的问题,专家们普遍认为:道路是曲折的,但前途是光明的。尽管中国在半导体封装领域取得了一定的进展,但与国际先进水平相比,仍存在差距。特别是实现cowos等高端先进封装中的材料和设备方面,目前国产化率相对较低,主要挑战包括设备核心零部件的自主研发能力不足、高端材料的国产化率低以及国际政治环境的不确定性。尽管如此,与会专家普遍对国产化的未来持乐观态度,认为通过产业链上下游的紧密合作,以及持续的技术创新,中国有望在先进封装领域实现自主可控。
对于国内封装厂商未来在国际市场定位和发展的问题,专家们表示,中国作为全球最大的半导体消费市场,国内终端产品竞争力强,技术的需求日益增长。自中美贸易战以来,国内芯片制造厂商技术上取得了显著进步,随着厂商的技术积淀和研发投入,不管是研发普通的FC封装、PLP封装也都会带动了先进封装的需求。同时,国际政治环境的变化促使一些海外设计公司将供应链布局转向中国大陆,进一步推动了国内产业链的发展。随着客户积淀和研发投入的增加,预计国内先进封装产业将迎来更大的发展空间。
对于如何看待晶圆级封装和板级封装的未来趋势,专家们指出,最初,板级封装主要是为了降低成本,早期的一些尝试,如使用基板线工艺和设备去实现晶圆级封装技术指标,到目前为止并没有成功。现在的板级封装技术越来越接近晶圆级封装的工艺,板级封装不仅仅是设备和工艺的改进,更是整个全新生态链的建立。尽管目前板级封装技术还存在一些挑战,如可靠性和良率问题,但市场对板级封装技术的信心正在增强。台积电的代工2.0计划将板级封装纳入计划中显示了板级封装技术未来的发展潜力。
对于先进封装材料国产化取得的进展和突破,道宜半导体研发总监陆海平指出,先进封装材料国产化率很低,国内企业正扮演着追赶者的角色,面临着后发劣势和客户对试错容忍度低的双重挑战。尽管可以直接借鉴先行者的经验,但材料成本和性能的平衡成为制约国产材料应用的关键因素。材料在产品中的比重虽小,却对性能至关重要,客户不愿因成本问题牺牲性能。中国材料厂商肩负重任,需从上游设计和制造环节着手,通过产业链协同,实现材料和设备的快速发展,以期在国际竞争中取得突破。
圆桌论坛的讨论充分展现了中国半导体产业在先进封装技术领域的发展现状和未来趋势。尽管面临诸多挑战,但与会专家们普遍认为,通过政策支持、技术创新和市场拓展,中国半导体产业有望在全球竞争中占据更加有利的地位。
金浦智能硬科技投资研讨会是金浦智能发起的系列主题研讨会,是公司管理团队、基金投资人、合作伙伴共同学习提升的平台。作为投资机构,唯有不断加深对行业的理解,才能挖掘出具有长期价值的优质标的。非常感谢各位来宾对金浦智能硬科技投资研讨会的关注与支持,金浦智能管理团队将继续砥砺前行,持之以恒地深入研究细分行业,致力于提供更优质的投资管理与增值服务,与合作伙伴一起在服务真实且高质量的科技创新之路上一直走下去,为促进新质生产力的发展做出应有的贡献!
金浦智能简介 金浦智能是金浦产业投资基金管理有限公司(“金浦投资”,成立于2009年)旗下专注于智能制造领域高科技企业股权投资的专业管理公司,管理的上海金浦临港智能科技股权投资基金合伙企业(有限合伙)由上海国际集团联合上海临港经济发展集团共同发起设立并由长三角地区地方国有投资平台、上市公司与民营企业共同参与,由金浦投资组建具有丰富资本运作经验和产业链资源的专业团队负责管理,目前管理的三个基金的实缴规模超30亿元人民币。金浦智能母公司金浦投资连续多年被清科、投中、融资中国、中国证券报、第一财经、中国风险投资研究院等机构评选为中国私募股权投资二十强。金浦智能成立以来已经连续多次被中国半导体投资联盟和中国母基金联盟评选为“年度最佳投资机构”,公司总裁田华峰博士也多次被相关机构评选为“年度杰出投资人”。基金多个已投项目也获得过相关机构评选的“年度最佳案例”、“IC独角兽”等荣誉。 |



