欢迎星标![]() ,以便及时接收最新的推送。
,以便及时接收最新的推送。
星标方式:打开微信公众号聊天界面,点击右上角 - 人物符号,再点击右上角 - 三个点符号,选择“设为星标”。


欢迎回来,本篇将继续对湿法去胶和湿法清洗工艺进行展开介绍。
点击下方,即可查看上篇稿件

延伸阅读:湿法工艺在微纳光学制造中的应用(上篇)
湿法去胶(STRP)
在微纳光学制造等领域中,光刻胶和压印胶占据了重要位置。对于光刻胶,主要是采用溶剂型去胶液进行去胶处理;对常用的压印胶等,主要是采用碱性去胶液进行去胶处理。在湿法去胶过程中,去胶液中的化学物质会与光刻胶发生反应,导致光刻胶分子的分解或交联网络结构的破坏,从而使其溶解或分解并从基材表面去除。
常见的湿法去胶液分为碱性去胶液、酸性去胶液、溶剂型去胶液和混合型去胶液,主要区别对比如下:
|
种类 |
常用药液 |
去胶原理 |
优缺点 |
|
碱性 去胶液 |
KOH、NaOH、TMAH |
光刻胶中的交联树脂在强碱的攻击下,酯键或酰胺键断裂,形成小分子片段,小分子溶于去胶液的溶剂中,从而实现去胶。 |
优点:性能强劲,无胶不摧,无胶不破,快速,经济。 缺点:钠离子,钾离子的污染,较易损伤金属。 |
|
酸性 去胶液 |
H2SO4+H2O2 |
硫酸和双氧水反应生成硫酸氢根(HSO₄⁻)和羟基自由基(OH⁻),可以氧化光刻胶中的有机物质,使其转化为更易溶于水的低分子量化合物,从而去胶。 |
优点:去胶速率快。 缺点:对金属不友好,只可在某些特定领域使用。 |
|
溶剂型 去胶液 |
NMP、DMSO、DMAC、丙酮、异丙醇等 |
溶剂分子渗透到光刻胶的网络结构中,通过破坏光刻胶分子之间的化学键,从而使其结构疏松并最终去除。 |
优点:温和,对玻璃晶圆无损伤。 缺点:速率慢,易挥发。 |
|
混合型 去胶液 |
由碱性、酸性、溶剂型去胶液中的任意两种组合而成,一般以碱性+表面活性剂居多。 |
既弥补了溶剂型去胶液去胶速率慢的劣势,又解决了碱性去胶液对底层金属的伤害问题。 |
优点:去胶速率快,对金属损伤小。 缺点:两种去胶液容易出现分层的问题。 |
1.碱性去胶液的去胶原理:
酯键断裂:RCOOR'+OH-→RCOO-+R'OH-
酰胺键断裂:RCONHR+ OH-→RCOO-+R'NH2
2.酸性去胶液的去胶原理:
第一步:H2SO4+H2O2→H2SO5(卡罗酸)+H2O
第二步:H2SO5+H2O2→羟基自由基(OH-)和硫酸氢根(HSO₄⁻)
第三步:羟基自由基(OH-)和硫酸氢根(HSO₄⁻)与光刻胶中的碳高分子链反应,最终生成CO和CO2。
3.溶剂型去胶液的去胶原理:
溶剂分子渗透到光刻胶的网络结构中,破坏光刻胶分子之间的化学键,使光刻胶结构疏松进而在去胶液溶剂中慢慢溶解,直至最终完全被去除。
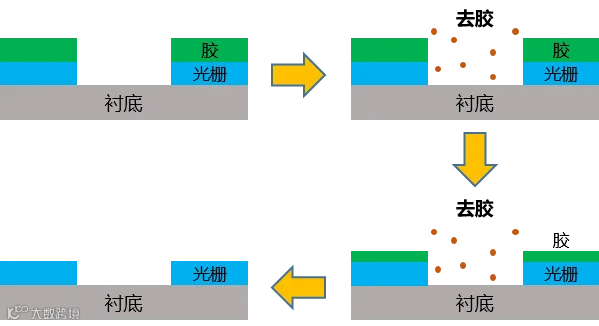
4.混合型去胶液的去胶原理:
以上三种去胶液任意两种组合后的综合(酸性和碱性去胶液不能组合)。
湿法去胶是一种在微纳光学制造等领域广泛应用的表面处理技术,除了需要根据药液性质选择合适材料做机台架构外,量产机台基本可以与湿法蚀刻机台通用。通过选择合适的去胶液和工艺条件,可以实现高效、彻底的去胶效果。对于湿法去胶的评价标准,通常从以下几个方面进行:
1.去胶效果:包括去胶速度、去胶彻底性(是否留有残胶)以及是否对晶圆表面造成损伤;
2.兼容性:考虑去胶液是否与晶圆上的其他材料(如金属层、介质层等)兼容,以避免在去胶过程中造成不必要的损害;
3.经济性:考虑去胶液的成本、使用寿命以及废液处理的难易程度;
4.安全性:评估去胶液对人体的毒性、易燃易爆性以及是否易挥发等安全隐患;
5.环保性:关注去胶液是否含有有害物质,以及废液处理是否会对环境造成污染。
湿法清洗(CLN)
在微纳光学制造的工艺流程中,每一个工艺步骤都有可能引入不同的污染物,面对不同的污染物就需要选择合适的药液对晶圆表面进行清洗,同时每款药液都有独特的组成配比,适用范围以及合适的反应温度等(如表1)。
|
种类 |
组成 |
工作温度 |
清洗对象 |
|
SC-1 |
氨水:双氧水:去离子水(1:1:5~1:2:50) |
50~70 ℃ |
晶圆表面的颗粒、轻微有机污染物及部分金属化污染物 |
|
SC-2 |
盐酸:双氧水:去离子水(1:1:5~1:1:50) |
50~70 ℃ |
去除金属离子,特别是碱金属离子和铝、铁、镁等金属的氢氧化物 |
|
SPM |
硫酸:双氧水(3:1~5:1) |
90~130 ℃ |
去除有机污染物,同时可以改善晶圆表面接触角 |
|
DHF |
氢氟酸:去离子水(1:50~1:1000) |
20~25 ℃ |
去除晶圆表面的氧化物层,如原生氧化层或化学清洗后生成的氧化层 |
|
BHF 和BOE |
氢氟酸:氟化铵 |
20~45 ℃ |
都适用于对硅片氧化层的清洗,因为添加了缓冲溶剂的作用,可以更加精细的调控清洗速率 |
表1:清洗液分类对比表
不同清洗液清洗原理:
1.SC-1溶液:双氧水作为强氧化剂,能够氧化碳化硅表面的颗粒,氨水则通过其碱性特性,轻微蚀刻氧化硅使颗粒下方与晶圆表面脱离,并通过电化学排斥力使颗粒从硅片表面脱离。

图1:SC-1溶液清洗原理[1]
2.SC-2溶液:通过盐酸与金属离子反应生成可溶性的氯化物,从而去除金属污染;双氧水在酸性条件下也能起到辅助氧化作用。
3.SPM溶液:又称食人鱼溶液,具有强氧化性,能有效去除晶圆表面的有机物污染。在高温下,硫酸可以使有机物脱水而碳化,而双氧水可将碳化产物氧化成一氧化碳或二氧化碳气体,从而被清洗掉。
4.稀释氢氟酸(DHF)、缓冲氢氟酸(BHF)和缓冲氧化物蚀刻剂(BOE):主要工作成分都是氢氟酸,主要工作原理都是通过氢氟酸与硅和硅的氧化物(如二氧化硅)发生反应,生成可溶性的氟硅酸或氟化硅气体,从而将硅片表面的氧化物和污染物去除。不同点在于,相比于DHF,BHF和BOE额外添加了缓冲溶剂可以更加精细地控制蚀刻和清洗速率。
此外,常用的清洗溶液还有EKC、DSP等,常被用来去除晶圆表面的化合物残留物,如光刻胶、蚀刻残留物等。EKC清洗液主要成分包括羟胺(HDA)、乙醇(DGA)、邻苯二酚(Catechol)以及水,主要基于化学溶解和去除机制,利用清洗液中的特定化学成分与晶圆表面的残留物发生反应,将其溶解或剥离。
小结
湿法去胶和湿法清洗工艺,不论是在集成电路制造还是微纳光学器件制造中,都扮演着重要角色,关乎着产品清洁度和产品良率,对于将来AR光波导的大规模量产有着重要的意义。
参考文献
[1] Michael Quirk, Julian Serda.半导体制造技术[M].北京:电子工业出版社,2004:126。

未经授权,任何人或机构不得以任何形式或方式转载、摘编或引用本文中的全部或部分内容,感谢配合。




