
据东湖国家自主创新示范区官网10月15日消息,近日武汉太紫微光电科技有限公司(简称“太紫微公司”)推出的T150A-光刻胶产品,已通过半导体工艺量产验证,实现配方全自主设计。
图1:东湖国家自主创新示范区官网新闻

该产品对标国际头部企业主流KrF光刻胶系列。相较于国外同系列产品UV1610,T150A在光刻工艺中表现出的极限分辨率达120nm,且工艺宽容度更大,稳定性更高,坚膜后烘留膜率优秀,其对后道刻蚀工艺表现更为友好,通过验证发现T150A中密集图形经过刻蚀,下层介质的侧壁垂直度表现优异。
光刻胶是现代微纳制造工艺的关键材料,广泛应用于集成电路、面板、PCB、LED等制造领域。光刻胶技术难度大、壁垒高,市场长期由少数日美厂商主导。近年来,随着市场、资金、人才、政策等多方面因素驱动,国内IC光刻胶及原材料厂商日益增多,国产高端IC光刻胶突破在望。
光刻胶是光刻工艺关键材料,
半导体光刻胶技术壁垒高
光刻胶是利用光化学反应经曝光、显影、刻蚀等工艺将所需要的微细图形从掩模板转移到待加工基片上的图形转移介质。其中曝光是通过紫外光、电子束、准分子激光束、X射线、离子束等曝光源的照射或辐射,使光刻胶的溶解度发生变化。光刻胶主要用于微电子领域的精细线路图形加工,是微制造领域最为关键的材料之一,自1959年被发明以来,光刻胶就成为半导体工业的核心工艺材料,随后被改进运用到印制电路板的制造工艺,成为PCB生产的重要材料;二十世纪九十年代,光刻胶又被运用到LCD器件的加工制作,对LCD面板的大尺寸化、高精细化、彩色化起到了重要的推动作用;近年来,光刻胶成为了决定半导体芯片制程水平的关键原材料。
图2:光刻工艺中光刻胶及各类电子专用化学品使用场景
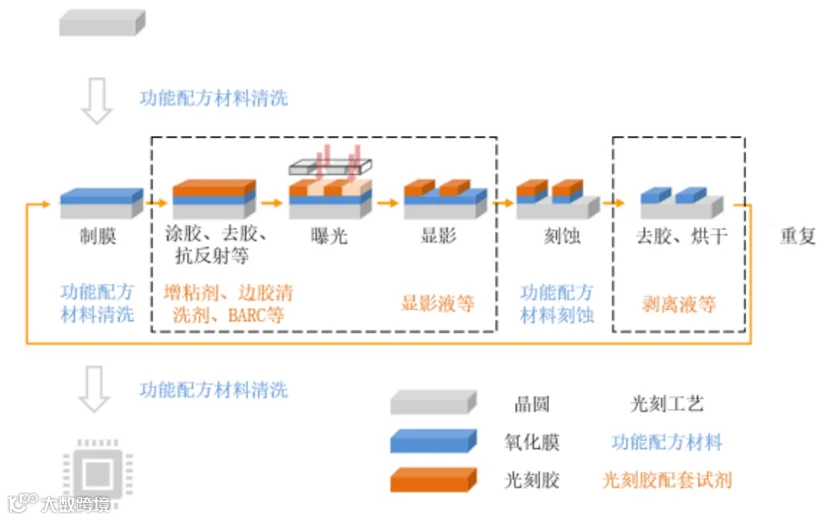
资料来源:瑞红苏州公开转让说明书
光刻胶按应用领域分类可分为PCB光刻胶、LCD光刻胶、半导体光刻胶三大类。光刻胶的分类按化学反应机理可分为正性、负性两大类,涂层曝光并显影后,曝光部分被溶解,未曝光部分留下来,为正性光刻胶,反之则是负性光刻胶。
图3:光刻胶按应用领域分类
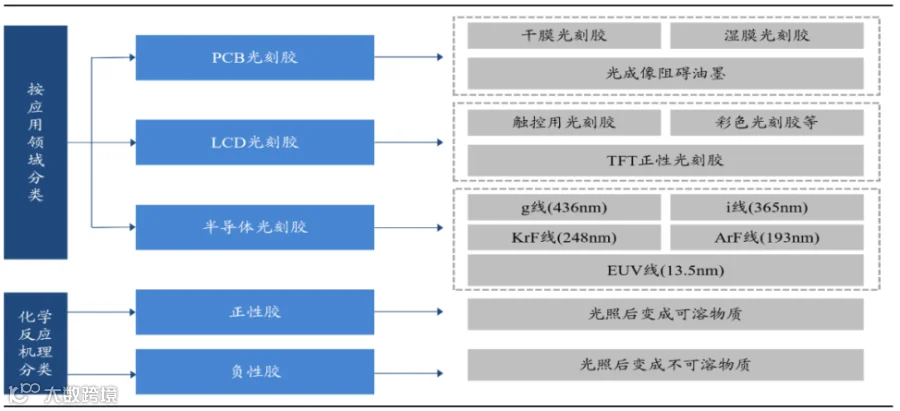
资料来源:行行查研究中心、开源证券研究所
光刻胶作为一种感光材料,在光线照射下会发生变化,是微电子技术中精细图形处理的重要环节,在电子信息、航空科技等行业得到广泛的应用。
(1)正性胶:一种在曝光前对某些有机溶剂不可溶,但在曝光后变为可溶的胶。当使用正性胶进行光刻时,在衬底表面将得到与光刻掩膜版遮光图案完全相同的图形。
(2)负性胶:在曝光后,与掩膜版一样的图形被紫外光曝光后的区域经历了一种化学反应,在显影液中软化井可溶解在显影液中。曝光的负性光刻胶区域将在显影液中除去,而不透明的掩膜版下的没有被曝光的光刻胶仍留在硅片上。正性光刻胶与负性光刻胶相比具有更高的对比度、抗刻蚀比与热稳定性,性质更稳定,更适合微电子领域的应用。
图4:光刻胶按照化学反应机理分为正/负性胶
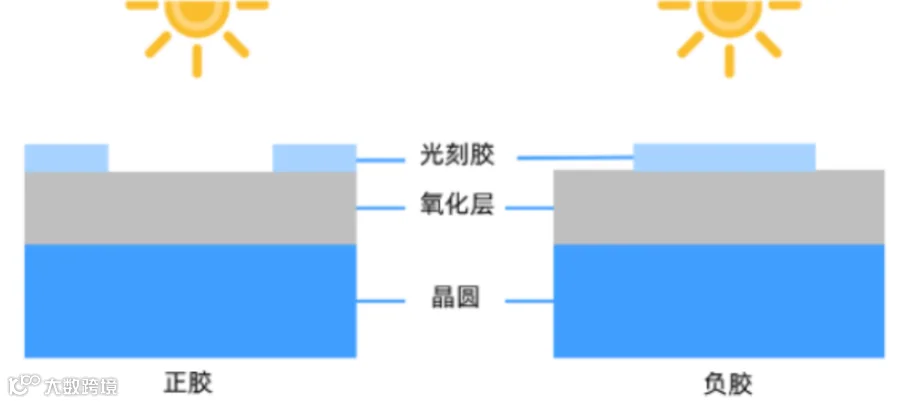
资料来源:行行查研究中心、LAMResearch
1.PCB光刻胶
印刷线路板的图案化工艺,已经从早期的丝网铜板印刷转变为更为精确和高效的光刻工艺,占比超过90%。PCB光刻胶主要分为干膜光刻胶、湿膜光刻胶、阻焊油墨。
(1)干膜光刻胶:由配置好的液态光刻胶均匀涂抹在载体PET薄膜上,经过烘干、冷却后,盖上PE薄膜,收卷而成的薄膜光刻胶。在使用时,将干膜光刻胶压在覆铜板上,经过曝光显影将电路图转移到光刻胶上。通过后续对覆铜板刻蚀加工,形成PCB上的铜线路,主要用于75-100μm制程。
(2)湿膜光刻胶:又称为感光线路油墨,分为抗电镀油墨和抗蚀刻油墨,与干膜工序相似,液态光刻胶均匀涂抹在覆铜板上,经过曝光、显影、刻蚀等工序形成铜线路,虽然材料成本比干膜要低,但是加工设备成本较高,主要用于25-75μm制程。
(3)阻焊油墨:用于在线路上形成永久的绝缘保护层,防止在焊锡过程中造成的短路,保证PCB在运输、存放、使用时安全性。进一步可以细分为UV固化阻焊油墨和液态感光阻焊油墨,UV固化油墨可用在对精度要求不高的PCB上,附着力较差;感光阻焊油墨则精密度较高。
图5:PCB制造过程中干膜光刻胶的应用
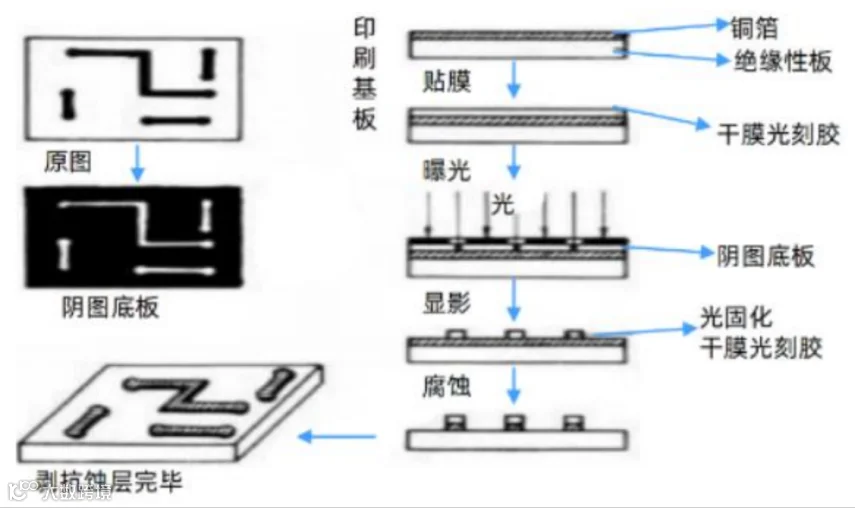
资料来源:强力新材招股说明书
2.FPD光刻胶
用于平板显示、显示器、LCD彩色滤波片制作等光刻工艺中,使用的光刻胶品种根据应用工艺不同主要分为TFT-Array光刻胶、彩色和黑色光刻胶等。
(1)TFT-Array正性光刻胶:主要应用于TFT-LCD或AMOLED制造中的Array段,包括TFT的图案化光刻胶,保护绝缘层光刻胶,ITO图案化光刻胶,OLED Array中平坦层光刻胶,OLED中PDL像素界定层光刻胶和Yocta制程用光刻胶。
(2)彩色&黑色负性光刻胶:彩色滤光片由玻璃基板、黑色矩阵、颜色层、保护层、ITO导电层等构成,用于实现LCD面板的彩色显示,彩色光刻胶(RGB)分为红、绿、蓝三原色光刻胶,经过涂抹、曝光、显影等工序组成了颜色层;黑色光刻胶则用于形成黑色矩阵(BM),起到防止漏光的作用,其中彩胶在FPD光刻胶中占比超过50%。
图6:彩色滤光片的结构和光刻工艺

资料来源:强力新材、中金公司研究部
3.半导体光刻胶
根据曝光波长的不同,半导体光刻胶可分为G线、I线、KrF、ArF和EUV五种类型。光刻胶曝光波长越短,则加工分辨率越高,能够形成更小尺寸和更精细的图案。随着集成电路制造技术的不断进步和器件特征尺寸的不断缩小,目前最先进的光刻胶曝光波长已经达到了极紫外光波长范围,如EUV(13.5nm)。
图7:半导体光刻胶分类

资料来源:中国科学院微电子研究所《光刻技术六十年》、ASML2022年年报、行行查研究中心、南大光电公告、开源证券研究所
G/I线光刻胶:G/I线光刻胶属于第一和第二代光刻胶技术,多数适用于6寸/8寸和438nm/365nm波长光源,目前成熟应用于汽车电子、MEMS等领域。
KrF光刻胶:KrF准分子激光器可发射波长为248nm的光波,主要应用于逻辑电路和3DNAND堆叠架构中。随着堆叠层数的增加,使用量将大幅提升。
ArF光刻胶:ArF准分子激光器可发射波长为193nm的光波,其中ArF干法光刻利用ArF光源进行光刻的工艺,光刻透镜与光刻胶之间是空气,光刻胶直接吸收ArF光源发出的紫外辐射并发生光化学反应;ArF湿法光刻利用ArF光源进行光刻的工艺,光刻机镜头与光刻胶之间的介质是高折射率的液体(如水或其他化合物液体),光刻光源发出辐射通过该液体介质后发生折射,波长变短,进而可以提高光刻分辨率,ArF湿法光刻常用于更先进的技术节点,如20-45nm。
EUV光刻胶:EUV是最新第五代技术,可以应用于7nm以下集成电路。主要用于先进的逻辑芯片和存储DRAM芯片制造。随着先进制成工序数量的增加,使用量将快速提升。
原材料:半导体光刻胶原材料性能要求高,技术难度大,依赖进口
光刻胶的原料包括光引发剂、树脂、溶剂、单体及其他助剂等。光引发剂对光刻胶的感光度和分辨率起决定作用;树脂是光刻胶的基本骨架,决定光刻胶的硬度、柔韧性、附着力、曝光前后溶解度变化程度、光学性能、耐蚀性能等基本性能;溶剂既溶解各种化学成分,也是后续光刻化学反应的介质。从成本结构来看,树脂成本占比最大,约50%,其次是添加剂(包括单体、助剂),占比约35%,光引发剂、溶剂成本合计占比约15%。
图8:光刻胶主要成分

资料来源:行行查研究中心、强力新材招股说明书、开源证券研究所
光刻胶树脂是光刻胶的主要成分之一,是由成膜树脂等构成。成膜树脂用于将光刻胶中不同材料聚合在一起,构成光刻胶的骨架,决定光刻胶的硬度、柔韧性、附着力等基本属性。
光刻胶树脂是高分子聚合物,具有高分子的一些物理特性,如成膜特性、Tg(玻璃化温度)。光刻胶的树脂也有一定的化学特点,它必须可以与在光照下光致产酸剂产生的酸反应,或发生脱保护(化学放大型光刻胶),或与其他组分结合(传统G/I线光刻胶),或发生交联(负胶),从而发生在显影液中溶解度的变化。以化学放大型光刻胶为例,树脂上有一个控制其在显影液中溶解的开关——不溶性悬挂基团,这个开关关闭时,树脂不在显影液中溶解;而在曝光过程中,光酸分解出的酸与不溶性悬挂基团反应,相当于把开关打开,使树脂能够在显影液中溶解,实现图形的转移。
晶圆上能够成功显现出刻画的图案,“开关”都在树脂上,可以说树脂是光刻胶的骨架,也是最核心的成分,因此光刻胶树脂对光刻胶的性能而言至关重要。树脂的结构设计涉及单体的种类和比例,会直接决定光刻胶在特定波长下可以达到的线宽(CD),也会影响ADR(碱溶解速率)的特性,从而决定曝光能量(EOP)等因素,甚至其他的性能,如EL(能量窗口)、LWR(线宽边缘粗糙度)等等。此外,树脂的分子量、PDI(分散度)等也会影响光刻胶的胶膜厚度、耐刻蚀性、附着力等,即树脂的质量决定了光刻“成画”的水平,而树脂质量的稳定性决定了每一幅画的水平是否稳定。
G/I光刻胶:G线光刻胶用环化橡胶树脂;I线光刻胶用酚醛树脂,单体为甲基酚和甲醛,这个酚醛树脂需要是线性的酚醛树脂,国产化程度很低,主要是依赖进口。
KrF光刻胶:KrF光刻胶用聚对羟基苯乙烯类树脂,单体为对羟基苯乙烯的衍生物单体,此类树脂目前基本也是依赖进口,原因之一是生产树脂需要的单体国内很少厂家供应,原因之二是树脂的生产工艺也有一定的难度,特别是后处理的工艺。
ArF光刻胶:ArF用聚甲基丙烯酸酯类树脂,单体为甲基丙烯酸酯和丙烯酸酯的衍生物单体,ArF的树脂由几种单体共聚而成,定制化程度比较高,国际市场上能够买到部分普通款的ArF树脂,但高端的ArF树脂几乎不卖。
EUV光刻胶:EUV用聚对羟基苯乙烯类树脂,或分子玻璃,或金属氧化物,国内由于设备受限,这块基本空白;高端的芯片封装光刻胶会用到PI和PSPI树脂,难度也很高,技术也掌握在国外几家厂商手里。
图9:半导体光刻胶树脂体系

资料来源:徐州博康公众号、东兴证券研究所
半导体光刻胶树脂技术要求高,看重企业对合成的KNOW-HOW的理解与积累。与非电子级树脂相比,半导体光刻胶树脂的主要区别如下:
(1)要做到质量一致,即分子量和分子量分布每批都要很接近,而且越是高级的树脂,越要做到质量一致。
(2)越高级树脂的分子量分布越小越好(理论值是1.0),EUV光刻胶树脂分子量分布都是接近1.02-1.05左右。
(3)金属离子要求越高级要求越高,现在大部分要求小于1ppb,甚至将来要到ppt级。比如与PCB的树脂相比,后者的合成对分子量和分子量分布没有很高的要求,金属离子也没要求。
在光刻胶树脂需求量逐步增长的背景下,中国大陆企业已加大光刻胶专用树脂业务的布局:半导体光刻胶树脂企业目前取得一定进展,部分企业已经能够少量供应,整体处于布局阶段;其中,徐州博康已经实现供应ArF和KrF原材料到成品光刻胶,八亿时空和彤程新材均实现KrF树脂量产,此外中国大陆显示光刻胶树脂企业主要供应TFT正胶用酚醛树脂并已实现量产。
光敏材料是光刻胶成分中真正“对光敏感”的化合物,是光刻胶的重要组成成分。半导体光刻胶用光敏材料主要分为PAG(光致产酸剂,简称光酸,Photo-Acid Generator)和PAC(感光化合物,Photo-Active Compound)。
PAG:则是主要运用于在化学放大型体光刻胶中,包括KrF光刻胶(聚对羟基苯乙烯树脂体系)和ArF光刻胶(聚甲基丙烯酸酯树脂体系)、EUV光刻胶,常温下为固态。
PAC:是重氮萘醌酯化合物,主要用于线性酚醛树脂体系光刻胶中,如g线/i线光刻胶。
图10:半导体光刻胶用光敏材料主要分为PAG和PAC

资料来源:徐州博康公众号、开源证券研究所
传统的光引发剂是光固化体系中的关键材料,常见的光固化体系包括UV胶、UV涂料、UV油墨等,由光引发剂、活性稀释剂、预聚体、助剂等原材料构成。光引发剂在直接或间接吸收光能后,本身发生化学变化,产生能够引发预聚体聚合的活性碎片(自由基、阳离子、阴离子等),从而引发预聚体聚合交联固化。
其中,PAC在光作用下从溶解抑制剂转变为溶解促进剂。而PAG则有所不同,它在吸收光之后产生酸,因此被称为“光酸”。在曝光后烘烤(PEB)过程中,这些酸会作为催化剂使得树脂上悬挂的酸不稳定基团脱落,从而改变树脂的碱溶解性,当足够多的悬挂基团脱落后,树脂就能溶于显影液。正是这一原理使得半导体光刻胶中的树脂在曝光区的显影液中可溶解,在非曝光区不溶解,最终实现光刻图形的转移。
图11:化学放大光反应示意图

资料来源:徐州博康公众号、开源证券研究所
简单结构的光酸合成和纯化难度低,但是复杂的、高端的光酸合成难度大,纯化比较困难。具体体现在:
(1)简单结构的光酸一步两步就可以合成,而复杂结构的光酸需要5-6步甚至7-8步的合成步骤,步骤越长,每一步可能产生的杂质越多,造成纯化困难,最终的收率也会越低。
(2)对于离子型光酸而言,其和金属离子同属离子态,性质有类似的地方,所以较难分开,这使得去金杂变得十分困难。
(3)纯度的检测也很困难,涉及离子型的化合物难以通过常规手段实现准确检测,比如HPLC或核磁并不能反应化合的真实纯度,这就要求研发机构拥有先进的检测设备
此外,光酸质量的稳定性主要体现在纯度的稳定,对于批量生产的光酸而言,实现金属离子含量小于10ppb相对比较容易,但要使每批光酸里的金属离子含量小于1ppb则十分困难,这是世界上头部企业才拥有的核心技术。因此,国内主要的光刻胶公司大多还是使用进口光酸。
目前,半导体光刻胶用的光敏材料主要还是依赖于海外进口,不同品质的光敏材料的价格差异巨大。根据徐州博康公众号数据,以国内PAG对应的化学放大型光刻胶(主要是KrF光刻胶、ArF光刻胶)来看,树脂在光刻胶中的固含量占比约10%-15%,对应的PAG用量为一般按树脂重量的6%-8%添加,最终PAG的成本占光刻胶总成本的10%-20%。其中,KrF光刻胶用PAG的价格在0.5-1.5万元/kg,而ArF光刻胶用PAG的价格约1.5-30万元/千克,价差可达20倍。在用量上,与KrF光刻胶相比,ArF光刻胶的PAG用量更少。和PAG相比,PAC在光刻胶中的用量大且价格低,一般来看,其在光刻胶中的使用量与对应树脂使用量差不多。
图12:ArF和KrF光刻胶的光敏材料价格高于i线光刻胶

资料来源:徐州博康公众号、开源证券研究所
溶剂在光刻胶含量占比中是最大的原材料。光刻胶溶剂的作用是将光刻胶中的树脂和感光剂溶解,使其均匀地涂布在硅片表面。溶剂可以调整光刻胶的粘度,使其适合涂覆过程。同时光刻胶溶剂还可以起到清洗、脱水等作用。在涂覆过程中,溶剂会从光刻胶中挥发出去,留下均匀的光刻胶膜层。溶剂需要能够有效地溶解光刻胶中的树脂和光敏剂,以确保光刻胶的均匀性和性能。
常用的光刻胶溶剂有丙二醇甲醚醋酸酯(PMA)、氯仿、苯等。光刻胶溶剂主要分为丙二醇甲联醋酸酯(PGMEA)、丙二醇甲联酷酸酯(PGMA)、异丙醉(IPA)等种类。丙二醇甲醚醋酸酯是性能优良的工业溶剂,对极性和非极性的物质均有很强的溶解能力,适用于高档涂料、油墨各种聚合物等的溶剂。
光刻胶作为半导体制造工艺中核心材料,研发难度较高,其工艺壁垒主要集中在配方的调试及较长的认证时间。
光刻胶的研发模式可以理解为一个不断进行配方调整的方法学过程,对经验的依赖性较大,且难以通过现有产品反向解构出其配方。厂商按照一定比例将原材料混合后进行光刻实验的验证,根据验证结果再进行配方调整,不断重复直至达到客户需要的性能指标。原材料比重的微调直接影响到光刻胶的各个性能指标:比如溶剂的多少会影响黏度;增稠剂能提高光刻胶成膜厚度;光引发剂的多少会影响光刻胶的灵敏度;碱性抑制剂的多少会影响光刻胶的线宽粗糙度;增感剂可以调节光刻胶的灵敏度和分辨率。此外,光刻胶在使用过程中也会使用一些配套辅助材料,如抗反射涂层(BARC、TARC、SOC等)用来吸收光刻过程中的反射光。
光刻胶的性能主要通过灵敏度、对比度、抗刻蚀比、黏度、保质期等指标来衡量。
灵敏度:衡量在曝光过程中,溶解性改变所需要的曝光剂量(ExposureEnergy)以及曝光过程中的响应速度,灵敏度太低会影响产出效率,太高可能会牺牲分辨率。
对比度:线宽粗糙度(LineWidthRoughness,简称LWR)衡量显影之后,由于边缘粗糙导致光刻胶线宽的偏离程度。
抗刻蚀比:衡量使用光刻胶与刻蚀材料在后续的刻蚀工艺下速率的快慢,耐刻蚀的光刻胶可以用来起到保护作用,确保覆盖区域不被刻蚀。
图13:光刻胶参数说明

资料来源:行行查研究中心、开源证券研究所
在实际生产过程中,光刻胶的性能指标往往需要根据具体的应用需求进行调整。比如在用作刻蚀保护时,需要光刻胶有一定的粘度和抗刻蚀比;在用于剥离工艺时,要考虑到光刻胶显影后的阶梯性;在先进制程中为了保证关键尺寸和剖面控制,对光刻胶的高刻蚀选择比要求高。因此,生产厂商往往会在一种型号的光刻胶目录下,有十个甚至几十个品种,以满足各方需求。在改进光刻胶性能时,则需要调整光刻胶的组成成分。
光刻胶的生产认证流程包括原料设计购买、配方工艺研制、客户端验证三个主要环节,认证流程复杂且成本昂贵。光刻胶的品质对光刻工艺和最终电子器件的性能影响很大,下游厂商非常重视光刻胶的质量以及厂商供货能力。光刻胶的客户端验证会经过严格的筛选流程,根据前瞻产业研究院的数据,一般PCB、FPD光刻胶验证过程为1-2年,而IC光刻胶则是2-3年。光刻胶客户端验证要经过三个阶段,第一阶段是离线测试阶段,对标现有产品;第二阶段是小批量产品测试;第三阶段是大批量产品测试阶段,客户通常会测试50个批次以上。在小试之前往往还要经过信息反馈和配方改进等步骤,最终大批量产品测试成功后,才可以获得订单。
除了对产品的性能进行验证以外,下游晶圆厂还需要对光刻胶厂商的工厂进行验证,以使光刻胶的供应稳定性得到保证。此外,光刻胶厂商的原材料供应商也必须得到下游晶圆厂的认可,甚至在更换供应商时要获得晶圆厂的同意。这些过程都有着极高的时间成本。
图14:光刻胶生产认证基本流程
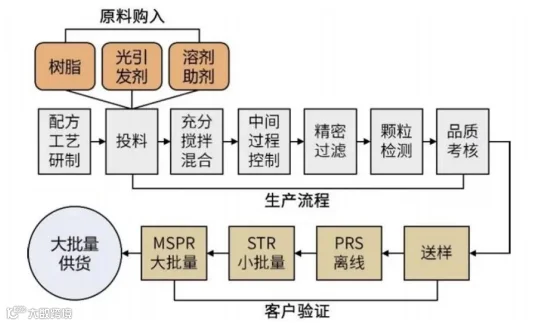
资料来源:中金公司
此外,光刻胶厂商需购置相关的光刻机来进行内部测试,随着光刻胶产品从低端向高端演进,用于测试配方的光刻机成本也越来越高,根据ASML年报计算,单台ArFi光刻机约需6000万欧元,EUV光刻机则需1.5亿欧元,由于全球仅ASML一家能批量供应EUV光刻机,其造价昂贵且供应数量有限,因此光刻胶供应商难以购买EUV光刻机进行内部验证,使得EUV光刻胶的研发成本及验证难度大幅提升。
稳定量产也是光刻胶制造的一大难点。稳定量产的难点主要在于:一方面是原材料的稳定供应,另一方面是放大量产过程中金属离子的控制。从实验室到工厂的生产放大,包括了树脂原料生产和光刻胶的生产。而实现树脂的稳定生产,是放大工艺的重中之重。树脂放大生中所涉及的核心参数——树脂的分子量、分子量分布、金属离子控制,都必须实现每批次间的稳定一致,才能够得到客户的青睐。
例如,ArF光刻胶对树脂的要求更高,比如树脂结构的均一性、批次之间的稳定性、树脂中的单体残留以及金属离子的控制,而由于定制化的特殊性,ArF光刻胶树脂很难在国外采购。金属离子控制方面,由于存在环境控制效果不一样、树脂后处理产品量不同、配胶时混合速度不一样且均匀度也不一样等问题,需要更高水平的提纯技术和经验。
近几年,国内厂商也开始布局和发展光刻胶原材料市场。从PGMEA厂商实现量产电子级产品开始,国内厂商逐步提高材料生产水平和产品品质,将产业布局从传统化工材料领域往纯净度要求更高的电子领域延伸,呈现逐步崛起的姿态。
目前国内厂商在光刻胶单体、树脂、光引发剂方面均有布局。溶剂的品种单一,生产技术壁垒相对较低,因此国产化程度最高。溶质部分,树脂和光引发剂的国产化程度较低,生产厂商较少,产品主要应用于PCB光刻胶和FPD光刻胶。IC高端光刻胶的树脂和引发剂在国内还存在较大空白。单体的国产化程度高于树脂,国内厂商已经实现用于KrF和ArF光刻胶的单体的小规模量产。
例如,强力新材除生产印制电路板(PCB)和液晶显示器(LCD)光刻胶专用化学品(光引发剂和树脂)外,还布局了半导体光刻胶光引发剂。公司半导体PAG系列光引发剂广泛应用于i线、KrF线半导体光刻胶领域,还可用于半导体封装材料领域。要想进入半导体光刻胶专用化学品市场,必须首先解决原料和产品提纯、生产工艺控制、金属杂质去除、异物混入防止、痕量分析检验方法、包装物流等诸多难题,对企业的研发能力、生产过程控制能力、品质监控和保证能力等都有非常高的要求。严格的客户评估、认证制度及持续的技术支持与服务也使得半导体光刻胶专用化学品的生产厂商和下游客户之间形成紧密的合作关系,一旦成功进入其供应体系,就很难被替代。强力新材基于多年的专业生产和研发经验,拥有单体功能性评价技术、特殊纯化技术、ppb级金属离子含量分析测试技术等系列的研发、生产和检测技术,能够生产高性能、高洁净度的光刻胶专用化学品。公司营业收入主要依靠PCB光刻胶专用化学品,半导体光刻胶光引发剂产品的占比逐步提升,成为公司的第二增长曲线。
海外龙头企业通常采用原材料外包的形式协助生产。由于海外光刻胶龙头厂商大部分掌握原材料的专利技术,会把单体、树脂、引发剂的生产外包给专业的树脂、中间体合成厂商,例如日本的三菱化学、丸善石化、旭有机材,韩国的美源商社,德国的巴斯夫、贺利氏等。这些负责原料生产的厂商均为化工龙头厂商,具有完备的生产线和技术支持,可以大幅降低光刻胶厂商的原料成本。由于光刻胶的生产技术壁垒极高,光刻胶厂商并不会担心外包中技术泄露,在配方调配中,树脂和光引发剂的品类较多,需要多种搭配,因此将原材料分散给多家厂商生产可以规避技术方面的风险。
另外一个明显特点是,由于海外原材料厂商都拥有几十年的技术积累,产品覆盖面广,在光刻胶原材料市场竞争中优势明显。比如成立于1950年的三菱化学,可覆盖全部光刻胶原材料的生产业务。韩国的美源商社也有多年单体、低聚物的生产研发积累,可覆盖除溶剂以外所有品类的光刻胶原材料。作为化学材料龙头,光刻胶原材料业务并非公司的主要盈利来源。此外,一些光刻胶生产厂商也在积极布局原材料供给能力,以增强自身的市场竞争力。例如龙头厂商杜邦自身就可以生产光刻胶单体和树脂聚合,富士胶片收购了IC光刻胶引发剂厂商和光纯药,TOK、JSR也投资了EUV光刻胶原材料厂商Inpria。
图15:光刻胶主要原材料国产化程度及国内外主要厂商

资料来源:中金公司
目前,全球光刻胶市场已达到百亿美元规模,市场空间广阔。我国光刻胶产业链逐步完善,且随着下游需求的逐渐扩大,光刻胶市场规模显著增长。2022年,我国光刻胶市场规模约为98.6亿元,同比增长5.68%,2023年约为109.2亿元。中商产业研究院分析师预测,2024年我国光刻胶市场规模可达114.4亿元。
图16:2019-2024年中国光刻胶市场规模趋势图

资料来源:中商产业研究院
全球半导体制程向着更先进、更精细化方向发展。根据ICInsights的统计和预测,在2019年,10nm以下先进制程的市占率仅为4.4%,而到2024年,预计其比例将增长到30%。在该时间段内,预计10nm-20nm制程的市占率将从38.8%下降到26.2%;20nm-40nm制程的市占率将从13.4%下降到6.7%。
图17:全球半导体制程向着更先进、更精细化方向发展
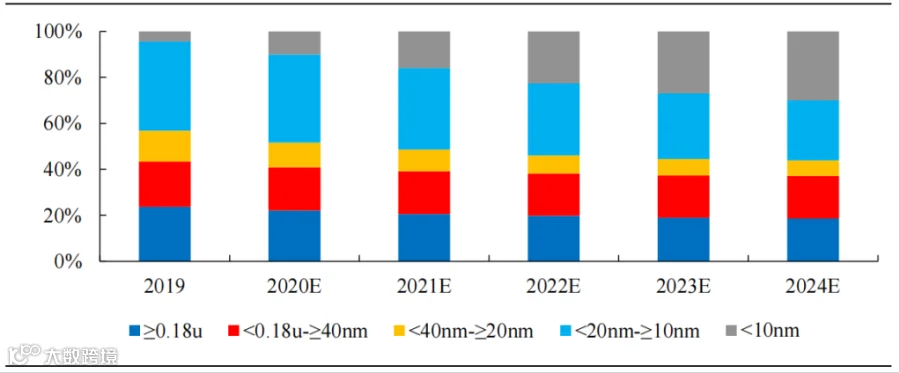
资料来源:ICInsights、SemiMedia、开源证券研究所
2024-2026年预计我国半导体光刻胶需求量快速复苏。根据势银(Trend Bank)预计数据,2023年下游市场疲软,半导体用光刻胶需求量也相应减少,2023年中国大陆半导体光刻胶总体需求量为1817.24吨,同比减少12.77%;其中,前五家晶圆制造厂商需求量达到894.65吨,占比49.23%。2024年,随着云计算、大数据、AI、自动驾驶等新兴领域的快速发展,算力芯片的效能要求逐步加强,多重挑战和趋势下,半导体行业将不断探索新的发展路径,半导体用光刻胶需求量及性能也将随之提升,尤其是高分辨率光刻胶以及厚膜光刻胶产品。预计2024-2026年中国大陆半导体光刻胶总体需求量增速分别为12.04%、11.50%和7.71%。
2024年5月24日,国家集成电路产业投资基金三期股份有限公司成立,法定代表人为张新,注册资本3440亿元,经营范围为私募股权投资基金管理、创业投资基金管理服务,以私募基金从事股权投资、投资管理、资产管理等活动,企业管理咨询。股东信息显示,该公司由财政部、国开金融有限责任公司、上海国盛(集团)有限公司、中国工商银行股份有限公司、中国建设银行股份有限公司、中国农业银行股份有限公司、中国银行股份有限公司等19位股东共同持股。大基金三期注册资本达3440亿元,超出一二期资本总和,有望加速推动关键领域的国产化进程,进一步加快成熟制程扩产,以及提供先进半导体设备/半导体材料等相关环节国产替代加速。
我国光刻胶行业发展起步较晚,生产能力主要集中在PCB光刻胶等中低端产品。根据中国产业信息网数据,中国PCB光刻胶占比达94%,而半导体光刻胶等高端产品仍需大量进口,自给率较低。未来,随着光刻胶企业生产能力的提高,我国光刻胶生产结构有望进一步优化。
图18:中国半导体光刻胶生产能力主要集中在PCB

资料来源:中国产业信息网、瑞红苏州公开转让说明书
我国光刻胶市场主要以日美企业为主。东京应化作为龙头企业占据25%-30%的份额,其次是美国杜邦占据15%-20%的份额、JSR与住友化学各占据15%-20%的份额,最后是DONGIN占据10%-15%的份额,富士胶片占据8%-10%的份额,其他白牌厂商占据5-7%的份额。未来我国有望打破国外技术垄断,积极推进研发,加快国产化速度。
图19:2023年我国光刻胶市场主要以日美企业为主

资料来源:行行查研究中心
半导体光刻胶国产化率低,未来国产替代空间广阔。从光刻胶国产化程度来看,生产技术难度较低的PCB光刻胶国产化程度较高,面板光刻胶和半导体光刻胶国产化程度很低,半导体光刻胶是技术难度和潜力较大的细分市场,其中g/i线光刻胶国产替代率相对较高,而EUV光刻胶国产替代化程度最低,目前还处于研发阶段。
图20:光刻胶国产化情况

资料来源:中商产业研究院
目前,国内已有多家公司有KrF/ArF光刻胶产品布局:
八亿时空:已于今年7月实现KrF光刻胶用PHS树脂百公斤级别的供货;
厦门恒坤新材:自主研发的KrF、ArF光刻胶已于6月通过大厂验证并实现产业化;
彤程新材:部分ArF/ArFi光刻胶产品已于4月开始批量供货;
上海新阳:KrF光刻胶已有销售,销量逐步增加,合肥工厂目前在试生产阶段;
晶瑞电材:多款KrF光刻胶已量产并供应多家半导体客户;
飞凯材料:光致抗蚀剂产品包括应用于半导体领域的i-line及KrF光刻配套Barc材料;
鼎龙股份:已开发出7款KrF光刻胶产品,包括1款能达到KrF极限分辨率120nmL/S和130nmHole的光刻胶;
南大光电:ArF光刻胶产品于2020年底通过客户认证,成为国内通过产品验证的第一只国产ArF光刻胶等;
徐州博康:ArF光刻胶在研及配方定型光刻胶有30款产品,其中立项ArF-immersion16款、ArF-dry14款,产品种类涵盖55nm、40nm、28nm及以下的LOGIC关键层工艺以及3DNAND、DRAM等应用领域。有4款ArF-immersion和6款ArF-dry光刻胶正在客户端进行产品验证,其中4款产品进入批量验证阶段。目前形成销售的Arf光刻胶有7款,其中1款ArF产品在12寸fab厂批量供应。KrF光刻胶在研和配方定型光刻胶有34款产品,其中,高分辨的KrF光刻胶,最小分辨率可达120nmCD,产品可应用于14nm-180nm制程中;KrF中厚胶,主要为L/S,针对8-12寸抗刻蚀层;KrF厚胶,主要针对高深宽比及高台阶覆盖的应用;KrF负胶,主要针对IC端和器件类特殊工艺应用;有20余款KrF光刻胶正在客户端进行产品验证导入量产,产品种类涵盖55nm、40nm、28nm及以下的关键层工艺以及存储器、分立器件、传感器等应用领域。目前形成销售的KrF光刻胶有16款,其中2款在国内大厂批量供应。
但是我国在推动光刻胶国产化的过程中,也面临着一些难点。不仅需要在光刻胶产品本身的研发和生产上取得突破,还需要在上游核心原材料和配方的国产化上做出努力,以减少对进口的依赖,因为目前国产的光刻胶原材料配方稳定性等较国外有差距。
中国想要在光刻胶领域掌握主动,打破垄断,要走的路还很远。首先还是要加大研发攻关,掌握核心技术。光刻胶本身复杂产线的行业性质,为打破垄断,缩短与日企的差距,我国企业的研发是多向发力,多点开花。最高端的EUV光刻胶主要有两种类型,一种是化学放大型(CAR),另一种是金属氧化物。今年4月,湖北九峰山实验室与华中科技大学的联合研究团队成功突破了“双非离子型光酸协同增强响应的化学放大光刻胶”技术。
图21:湖北九峰山实验室与华中科技大学的联合研究团队研发成果

资料来源:知网
这种光刻胶能在曝光后产生更多酸,从而提高成像质量,减小线宽粗糙度,以更高灵敏度和分辨率来适应更先进更复杂的集成电路制造工艺。
目前最顶级的EUV光刻机中,光刻胶的技术难度之一就是普遍对光源的敏感度不足,这不仅制约了产量,也推高了光刻机及其配套光源的制造难度和成本。去年10月,清华大学与浙江大学的联合团队全球首次提出了“点击光刻”新方法,并成功研发出与之匹配的超高感光度光刻胶样品。
图22:清华大学与浙江大学的联合团队研发成果

资料来源:知网
这种新型的光刻胶材料,能在极低曝光剂量下实现高对比度成像,大大降低了光刻曝光剂量,提高光刻效率。
其次,光刻胶技术尽快产业化。光刻胶,技术突破只是一个方面,不能只看专利和论文,最终还是要看落地到产业的情况。在A股,目前有约20只光刻胶相关的股票,代表着中国光刻胶领域的中坚力量。
最后,要建立光刻胶的产业生态。除了技术突破和产业化,更重要的是形成自己的产业生态体系——与下游企业深度合作,即要有自己的光刻机。全球光刻机行业里,几乎是美日企业的天下,荷兰ASML供给了全球92%的高端光刻机。目前,我国光刻机的国产化率不足3%,2023年进口光刻机数量高达225台,进口金额高达87.54亿美元,创下历史新高。以产品来说,仅有上海微电子能制造90nm工艺节点DUV光刻机,与ASML差距极大。
未来10年将是国内光刻胶产业发展机遇期,龙头厂商将会不断拓宽自己的产品线和应用面,积极开发新产品和扩建产能;新厂商则会聚力于攻关某一种光刻胶产品,使得整个国内IC光刻胶行业呈现百舸争流的景象。用于先进制程和成熟制程的高端光刻胶(EVU、ArF、KrF)市场空间较大,国内需求增长较快,建议关注在中高端IC光刻胶研发方面进展较快的光刻胶厂商,以及掌握核心技术的光刻胶原材料厂商。

来源:常州投资集团博士后创新实践基地/龙城产业技术研究院
编辑:康狄 陈希
审核:文小明 蒋雅君


