
金属互连工艺的重要性愈发凸显,而ECP(电化学电镀铜)工艺凭借高效填孔、低电阻、高可靠性的优势,成为7nm及以下节点芯片互连的主流方案。很多人好奇,ECP电镀铜究竟靠什么支撑先进制程的互连需求?其背后的电化学原理与工艺细节,藏着半导体芯片微型化的关键逻辑。
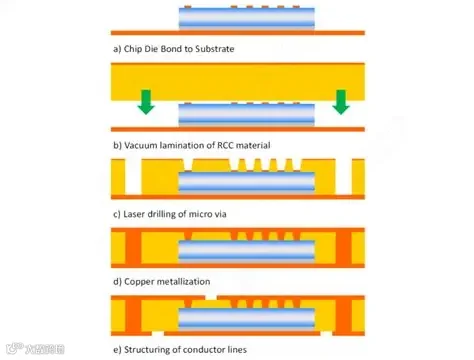
ECP电镀铜的核心是依托电化学还原反应,实现铜层的精准沉积与通孔填充,这也是其区别于物理气相沉积(PVD)、化学气相沉积(CVD)的核心逻辑。从原理来看,电镀过程中,待镀晶圆作为阴极,铜电极作为阳极,硫酸铜溶液作为电镀液,接通直流电源后,电场驱动电镀液中的铜离子(Cu²⁺)向阴极移动,在阴极表面获得电子发生还原反应,沉积为金属铜原子,最终形成均匀的铜薄膜及互连线路,完美适配芯片互连中Via孔、沟槽的填充需求。
一套完整的ECP电镀铜工艺,需经过“种子层制备—电化学镀铜—洗边—退火”四大核心环节,每个步骤都直接决定互连质量。其中,种子层制备是基础前提:由于铜与半导体材料粘附性差且易扩散,需先通过PVD工艺淀积一层约500Å厚的铜籽晶层,既能提升后续铜层的附着性,也能为铜离子还原沉积提供稳定基底,避免出现铜层脱落、扩散导致的器件失效。
电化学镀铜环节的核心难点的是通孔的无缺陷填充,而三类添加剂的协同作用是关键。加速剂可加快孔底铜离子还原速度,推动填孔自下而上进行,避免孔内形成空隙;抑制剂能在阴极表面形成阻化膜,减缓孔口和晶圆表面的铜沉积速度,防止孔口过早封堵导致的空洞缺陷;整平剂则通过调控不同电流区域的铜还原速率,提升镀层表面平整度与均匀性,减少晶界缺陷。三者的配比与协同控制,是ECP工艺适配先进制程的核心技术壁垒。
电镀完成后的洗边与退火工艺,是保障互连可靠性的“收尾关键”。洗边采用硫酸与双氧水混合溶液,去除晶圆边缘2-5mm的铜残留,一方面可消除边缘毛边,避免后续出现铜起皮(Cu peeling)或电弧(arcing)问题;另一方面能优化边缘形貌,为晶圆级键合筑牢基础——边缘铜残留会导致键合压力不均,引发崩边、气泡缺陷甚至晶圆翘曲,直接破坏3D互连结构。
退火工艺则是通过150-200℃、30-60s的加热处理,实现铜层性能优化:既能降低铜层体积电阻、改善电子迁移率,提升信号传输效率;也能减少镀层晶界、改善面缺陷,增大后续化学机械抛光(CMP)的研磨率,同时延长器件使用寿命,适配高功率、高频芯片的长期稳定运行需求。
ECP电镀铜工艺的崛起,是先进制程芯片互连微型化、高性能化的必然选择,其每一个工艺环节的精准控制,都直接关联芯片的互连质量与可靠性。随着制程持续迭代,通孔尺寸缩小、互连密度提升,对ECP工艺的添加剂协同、精准控温、缺陷控制提出更高要求。




