
很多新手以为ECP只是简单的“给晶圆镀层铜”,实则不然,ECP是先进制程芯片互连的核心,直接决定芯片的信号传输速度、良率和使用寿命。
ECP电镀铜基于基础电化学原理,简单说就是“用电场让铜离子沉积成膜”——在电镀槽中,待镀晶圆作为阴极,含有铜离子的溶液作为电镀液,阳极通常采用纯铜电极。当接通直流电源后,电场作用下,电镀液中的铜离子(Cu²⁺)会向阴极移动,在阴极表面获得电子发生还原反应,还原为金属铜原子,均匀沉积在半导体基片表面,最终形成致密的金属铜薄膜,用于芯片内部的互连线路和接触电极。
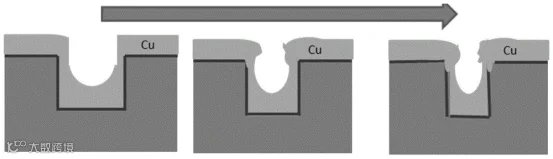
这里必须强调:ECP电镀铜不是孤立工序,而是一套完整的工艺体系,核心分为四大步骤,每一步都不能出错,否则直接导致良率崩盘。第一步是前工序——种子层制备,这是很多新手容易忽略的关键环节。由于铜与半导体材料的粘附性极差,且铜容易在介质中扩散,会破坏芯片性能,因此必须先用PVD等方法,淀积一层厚度约500Å的铜籽晶层。这层种子层就像“地基”,既能增强铜镀层的附着力,又能引导后续铜离子均匀生长,为电镀环节筑牢基础,种子层的均匀度直接影响后续铜镀层的缺陷率。
第二步是核心的电化学镀铜环节,也是整个工艺的“灵魂”。将制备好种子层的晶圆放入电镀槽,施加稳定的直流电,铜离子会在种子层表面定向沉积,重点填充刻蚀后的Via孔区域,形成芯片所需的金属互连线路。这里的关键的是电镀液中的三类添加剂,它们被誉为“ECP工艺的调味剂”,直接决定填孔效果,三者协同作用,缺一不可。
三类添加剂的作用必须分清,这也是Fab厂良率控制的核心要点。第一类是加速剂,核心作用是加快孔底铜离子的还原速度,推动铜沉积自下而上进行,避免孔内出现空洞;第二类是抑制剂,会在晶圆表面形成一层阻化膜,减慢孔口和表面的铜沉积速度,防止孔口过早封堵,导致孔内无法填实;第三类是整平剂,能在高电流区抑制铜还原,在低电流区促进铜还原,提升镀层表面的平整性和均匀性,减少孔内缺陷。根据半导体论坛同行分享,添加剂的配比误差哪怕只有0.1%,都可能导致填孔不良,良率直接下降10%以上。
电镀完成后,并非万事大吉,后续的洗边和退火工序,是保障铜镀层性能的最后一道防线。第三步是洗边工艺,采用硫酸和双氧水的混合溶液,去除晶圆边缘2-5mm的铜层。很多人疑惑为什么要洗边?核心目的有三个:一是去除边缘毛边,防止后续出现铜起皮或电弧;二是优化边缘形貌,为后续键合工艺铺路;三是避免边缘铜残留影响晶圆级键合质量,否则会导致键合界面鼓起、晶圆翘曲,甚至芯片失效。
第四步是退火工艺,洗边后将晶圆加热至150-200摄氏度,保持30-60秒。这一步的核心作用的是优化铜镀层的微观结构:一是降低铜层的体积电阻,改善电子迁移率,提升信号传输速度;二是减少镀层中的晶界,改善面缺陷,延长芯片使用寿命;三是增大铜晶粒尺寸,提升后续CMP的研磨率,提高生产效率。结合Fab厂实操经验,退火温度过高或时间过长,会导致铜层氧化;温度过低则无法达到优化效果,这也是实操中需要精准把控的参数。
可能有家人会问,ECP电镀铜为什么能成为先进制程的核心?要知道,随着芯片制程进入14nm及以下,铝互连已无法满足高频、高集成的需求,而铜的导电性、导热性远超铝,ECP工艺能实现高深宽比Via孔的均匀填孔,完美适配先进制程的互连需求。从行业发展来看,ECP电镀铜已成为12英寸晶圆制造的主流工艺,应用材料、Lam Research等巨头的ECP设备,更是Fab厂的核心设备。




