本文转载自CSDN论坛作者主公讲ARM的博客,转载文章仅供学习和研究使用。
Overview
D2D(Die-to-Die)互联
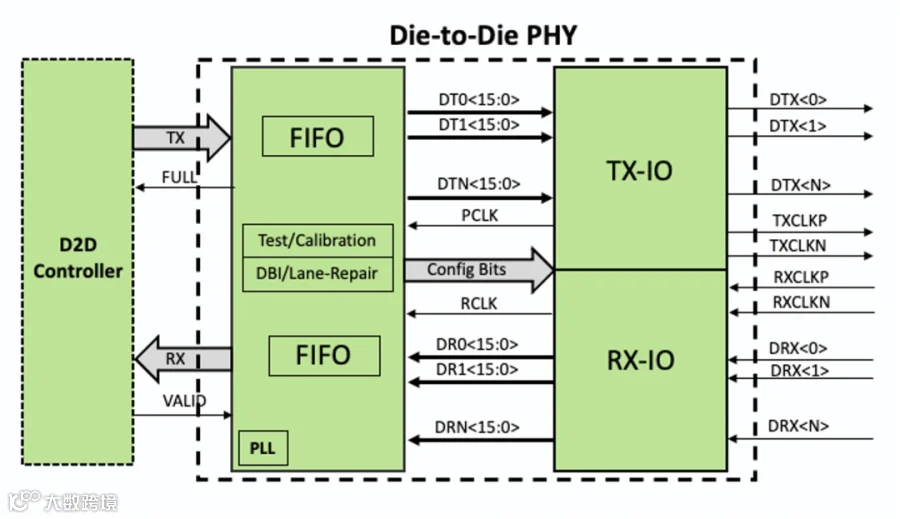
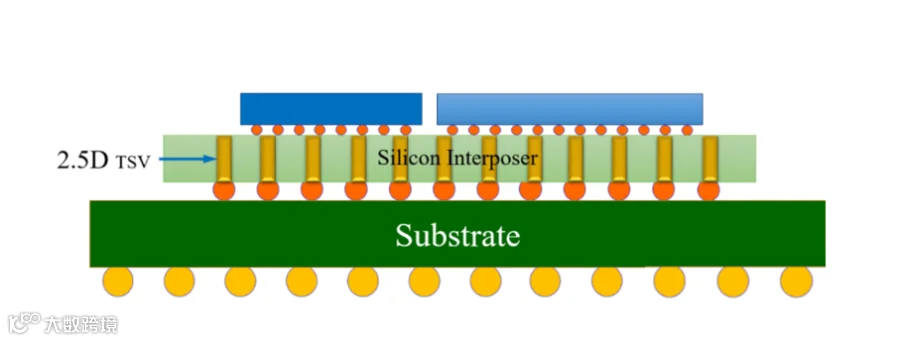
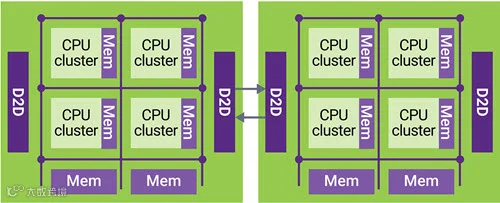
-
高性能计算(HPC):如处理器和高带宽存储(HBM)之间的连接。 -
人工智能芯片:多模块间实现低延迟的高效数据交换。 -
先进封装技术:2.5D封装中的有机互连基板或硅中介层,3D封装中的硅通孔技术。
C2C(Chip-to-Chip)互联
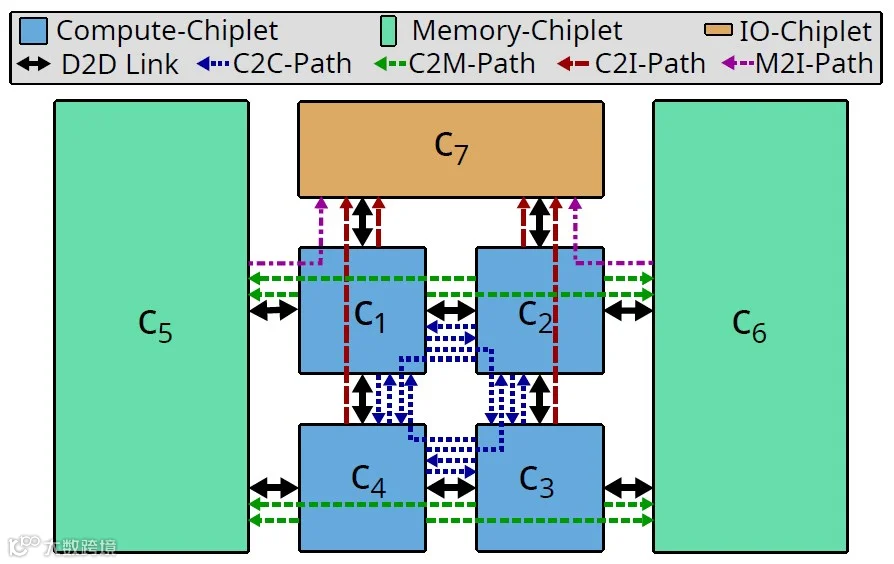
-
数据中心:服务器主板上CPU和GPU之间的通信。 -
消费电子:智能手机主板上处理器和外部存储器之间的连接。 -
高速网络设备:如交换芯片或不同模块之间的数据传输。
D2D和C2C的差异总结

实际案例
-
技术特点:使用2.5D封装,通过RDL层进行信号互连。 -
应用场景:GPU(如NVIDIA H100)和AI芯片中,用于提升数据读写速度。
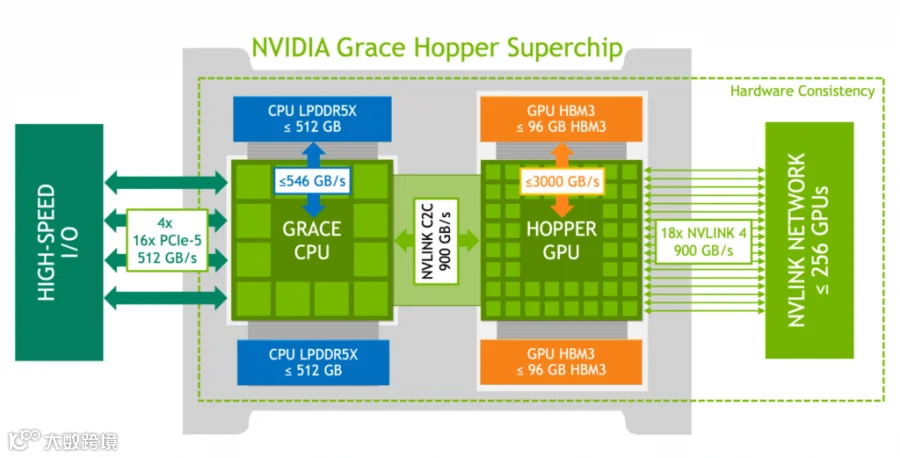
-
技术特点:基于主板的铜导线信号传输,支持多设备之间的并行通信。 -
应用场景:通用计算设备、服务器和消费电子。
-
技术特点:利用成熟的以太网堆栈实现长距离通信。 -
应用场景:数据中心内的高速芯片通信。
总结
往期推荐
|
|||
|
|||
|

牛芯半导体(深圳)有限公司(简称“牛芯半导体”)成立于2020年,聚焦接口IP的开发和授权,并提供相关整体解决方案,致力成为全球领先的IP供应商。
牛芯半导体在主流先进工艺布局SerDes、DDR等中高端接口IP,产品广泛应用于消费电子、网络通信、数据存储、人工智能、汽车电子、医疗电子等领域。
未来,牛芯半导体持续响应IP市场需求,适应不断演进的接口技术和日益拓展的接口互联场景,赋能数智时代下的千行百业。


