本文转载自智能计算芯世界,转载文章仅供学习和研究使用。
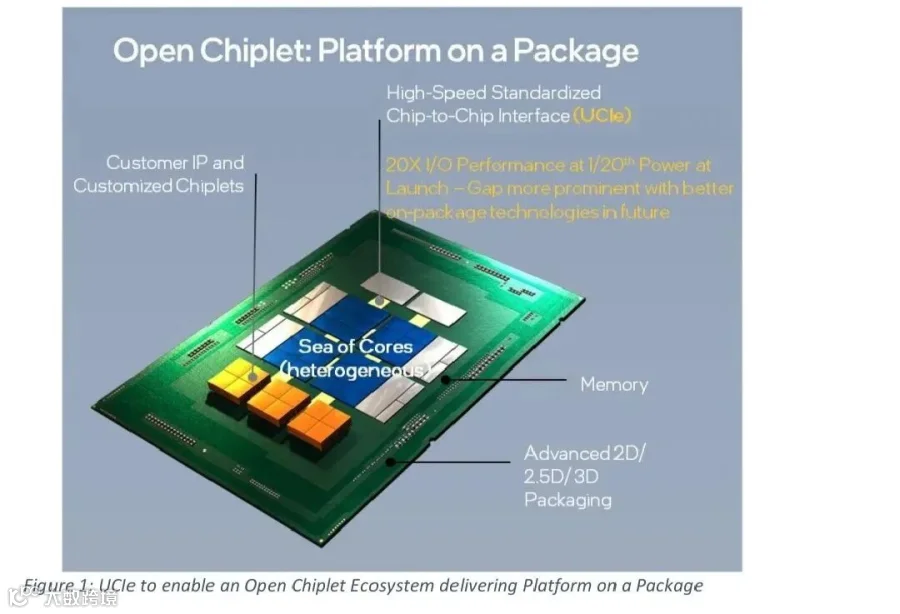

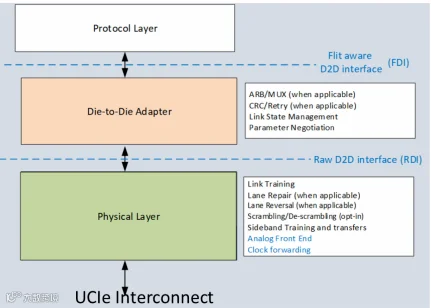
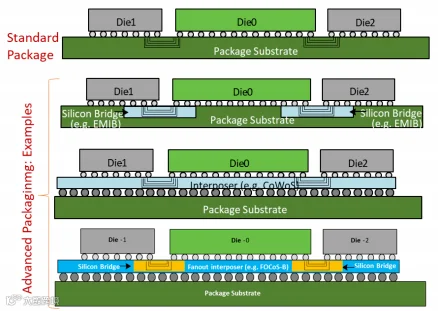


往期推荐
|
|||
|
|||
|

牛芯半导体(深圳)有限公司(简称“牛芯半导体”)成立于2020年,聚焦接口IP的开发和授权,并提供相关整体解决方案,致力成为全球领先的IP供应商。
基于自主可控的核心技术,牛芯半导体在主流先进工艺布局SerDes、DDR等中高端接口IP,产品广泛应用于消费电子、网络通信、数据存储、人工智能、汽车电子、医疗电子等领域。
未来,牛芯半导体持续响应IP国产化需求,适应不断演进的接口技术和日益拓展的接口互联场景,赋能数智时代下的千行百业。


