今天,光华君再次为大家带来研发部门的干货,欢迎交流探讨~
SOC制程在微盲孔填镀中的缺陷及改善
刘彬云、肖亮、苏从严
(广东东硕科技有限公司,广东省 广州市 ,邮编 510288)
摘要(中文):
选择性有机导电聚合工艺(SOC, Selective Organic Conductive Polymerization)是一种绿色环保的工艺,代替传统PTH进行孔导通化,具有制程简单、环保节能的特点,但因其导电性不如PTH沉铜层好,且没有金属做铜生长的晶核,在电镀时往往存在镀层不连续或深镀能力差的现象,特别是盲孔玻纤处容易出现孔破的问题,需要通过改善SOC制程和预镀的工艺参数,加强生产过程中的品质控制,达到理想的电镀微盲孔品质,来满足生产的要求。
关键词(中文):
选择性有机导电聚合、闪镀、盲孔填镀
国务院印发《“十三五”节能减排综合工作方案》,要求各地区、各部门认真贯彻落实部署,把节能减排作为优化经济结构、推动绿色循环低碳发展、加快生态文明建设,降低化学需氧量、二氧化硫、氨氮、氮氧化物等主要污染物排放总量,环境改善。
近年来,清洁生产的意识已被广大的制造业者认同,使用环保节能的新工艺和材料也是制造业的一大热门,选择性有机导电聚合工艺(SOC,Selective Organic Conductive Polymerization)工艺作为一种新工艺逐渐取代传统的化学沉铜工艺,它采用有机物单体原位聚合在绝缘的孔壁上,目前基本上都是采用聚噻吩作为导电层。
相对于传统的化学沉铜工艺而言,SOC工艺具有诸多的优点:首先是流程短,生产效率高,使用原材料和排污量少,无甲醛无络合剂和重金属,废水也比较易处理,对环境和操作人员身体健康危害性小,同时还节水省电,成本相应的降低,生产可自动化,符合智能化生产的发展趋势,得到PCB制造业的初步认同和大力推广。
另一方面,电子互联随着便携式可穿戴等设备的新要求,PCB朝着超薄、微小型和多功能的方向发展,微导通孔的发展成了当今的PCB发展的主要途径。SOC工艺虽然在PCB制造行业已经推广,但目前还只是应用于中低端印制电路板的制造,主要原因是它是一个新的工艺,一段时间内还未能得到广大PCB制造商的认同和接受,对于一种新的工艺是否能够完全替代传统的工艺,稳定性和可靠性怎样,怎样去更好地管控它的生产品质,都是业界比较关注的问题。
当然,在微盲孔的生产制造过程中,SOC工艺确实出现过一些品质问题,特别是孔破这种不可接受的缺陷,给它的推广带来了严重的影响,需要我们对此流程进行改进和提高。下面就以SOC工序应用于微盲孔的制造过程中出现的问题进行分析和改善。
一、盲孔导通化中填镀制作的工艺流程
传统PTH在做盲孔电镀时,通常有两种方式,即有闪镀和直接填镀两种,工艺流程如下:
A、 化学镀铜+盲孔填镀(PTH+VFP)工艺流程
除油->微蚀预浸->活化->化铜->酸浸->电镀填孔
这是一个比较方便快捷的流程,特别是对于需要做精细线路的电路板,需要控制面铜的厚度,如果直接在PTH后填孔,表面铜厚能得到有效地控制,特别是最新的高效填镀添加剂的应用,表面铜厚可控制在15μm以下,一般不需要再去减铜就可以直接做精细线路。
当然,这种工艺对盲孔的钻孔质量要求较高,对PTH和填镀工艺的控制较为严苛,稍有不好就会出现填镀不良造成凹陷(Dimple)过大或漏填等问题(如下图一所示)。

图一、PTH盲孔填镀凹陷情况
B、 化学镀铜+闪镀+盲孔填镀(PTH+FP+VFP)工艺流程
除油->微蚀->预浸->活化->化铜->酸浸->闪镀->微蚀->酸浸->电镀填孔
这个流程与A相比,就是多了一个闪镀。当然,如果工厂的流程设计合理,闪镀是可以放在PTH后或填孔前,对于操作层面来说没有增加实质性的动作,主要是在闪镀时孔铜和面铜同时在增长,这样在后续填孔电镀后,面铜比A流程会有所增加,如果需要做精细线路,需要精确计算完成填镀后面铜的厚度,必要时需要通过减铜来达到表面铜厚的要求。
但是,这种工艺对盲孔的钻孔质量要求没有那么高,特别是对有孔口悬铜、孔内玻纤突出的不良盲孔,这个工艺流程是一个不错的选择。图二为PTH后有闪镀的填孔效果。
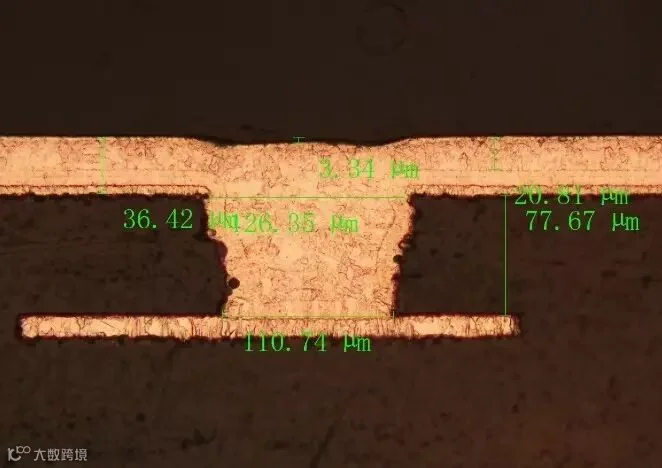
图二、完美的PTH盲孔填镀
C、 SOC后直接采用盲孔填镀(SOC+VFP)工艺流程
调整->引发->聚合->酸浸->电镀填孔
这是一个最方便快捷的流程,流程短、排污低、节能高效,表面铜厚能得到有效地控制,适合做精细线路的电路板。当然,这种工艺对盲孔的钻孔质量要求更高,最好是没有悬铜和孔壁突出的玻纤,而且SOC的制程控制较为严苛,对于盲孔而言,SOC导电性不如PTH沉铜层好,且没有金属做铜生长的晶核,填镀铜时首先铜会在孔口盲孔底部开始长铜,并双向向中间延伸到盲孔中部直至整个孔镀上一层铜,整个长铜过程仅需1min以内,其后电镀过程与PTH电镀过程一致。填镀药水也需要有一个好的上铜速率表现,不同的材料也会影响盲孔的填镀品质,比较容易出现填镀不良造成凹陷过大、空洞甚至漏填等问题(如下图三所示)。

图三、SOC盲孔填镀漏填情况
D、 化学镀铜+闪镀+盲孔填镀(SOC+FP+VFP)工艺流程
调整->引发->聚合->酸浸->闪镀->微蚀->酸浸->电镀填孔
为了保证SOC做微盲孔有一个好的填镀品质,而且拥有流程短、排污低、节能高效的效益,选择上面的流程。当然,这种工艺对盲孔的钻孔质量要求不需要太苛刻,当然SOC的制程控制需要得到稳定良好地控制,闪镀药水也需要有一个好的上铜速率表现,并可以适应不同的材料,比较容易得到较好的闪镀层,从而保证填镀品质(如下图四所示)。如果配以新一代面铜较薄的填孔药水,表面铜厚能得到有效地控制,适合做精细线路的电路板。下面针对SOC在盲孔填镀应用方面的问题分析与改进措施。

图四、完美的SOC盲孔填镀
二、SOC在制作盲孔填镀过程中的问题分析与改进
从以上分析,我们推荐采用D流程做为HDI盲孔的制作流程,本次生产的是二阶的盲孔,线宽间距在75μm以上,因此没有面铜厚度偏大的压力,采用的闪镀工艺上铜也好,一般在5mm/min以上(要求2-8mm/min)。因此重点探讨SOC制程的工艺控制。下面是初始的控制参数及要求:

按正常的闪镀(6μm)和填孔流程进行后续填镀流程,我们对填孔后的板进行漏填检查,发现有漏填率在5%以上,主要表现在漏填、包芯、凹陷过大等几个方面,如下图示:

图五、SOC盲孔填镀漏填情况

图六、SOC盲孔填镀漏填情况

图七、SOC盲孔填镀包芯情况

图八、SOC盲孔填镀凹陷过大
面对此缺陷,我们第一时间反应判断为可能为闪镀能力差,针对闪镀已经选择了比较好的添加剂系列,我们还是在闪镀后取切片进行分析确认,结果如下:
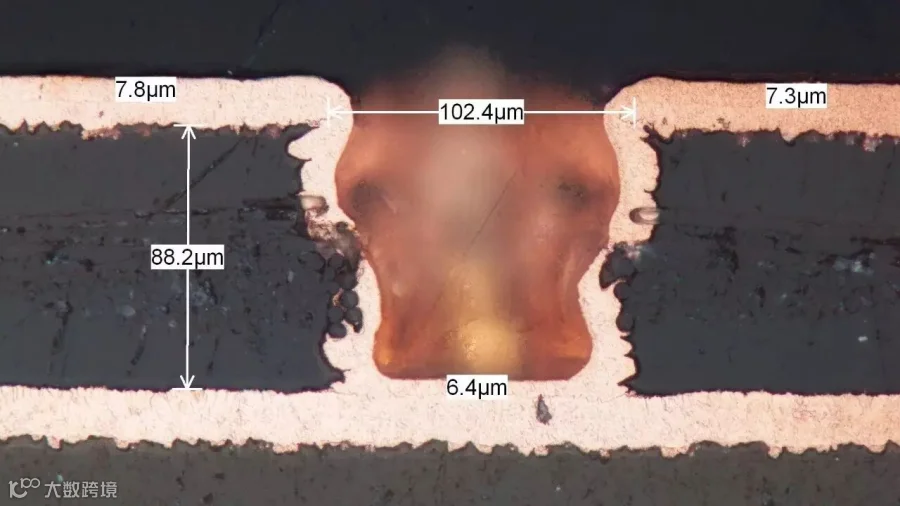
图九、SOC盲孔闪镀不良情况1
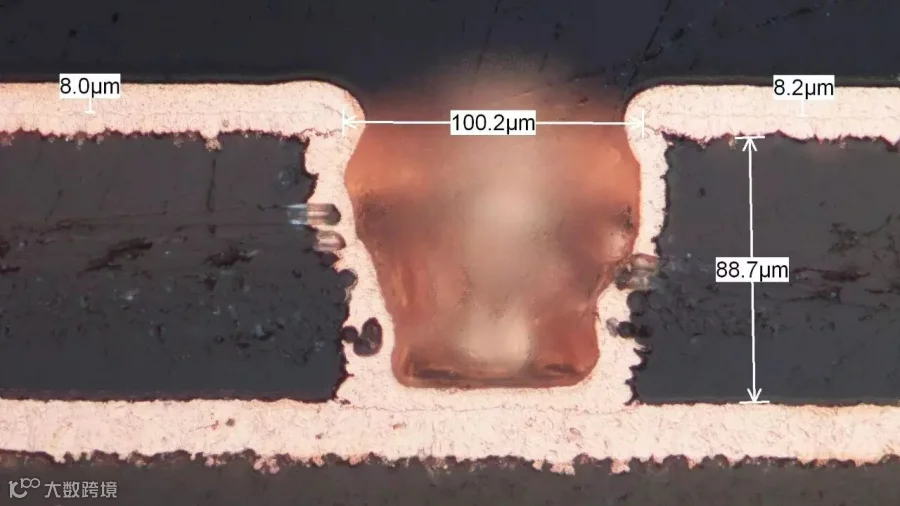
图十、SOC盲孔闪镀不良情况2

图十一、SOC盲孔闪镀不良导致漏填
由上图可以看出,部分闪镀层未能很好的覆盖盲孔中的玻纤,导致填孔失败,说明本次问题出现在SOC制程对玻纤的调整上。通过对调整剂的改进,使用新的调整剂,终于换得了良好的闪镀效果。
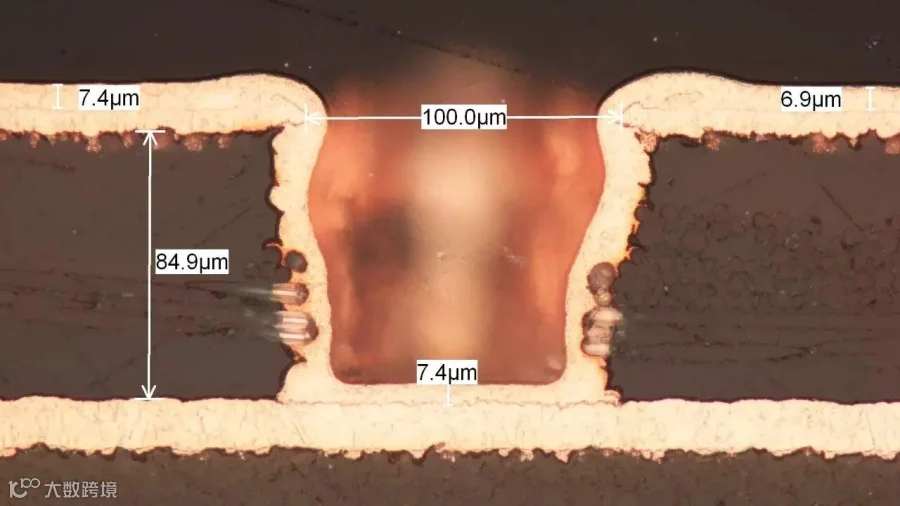
图十二、SOC盲孔闪镀良好1
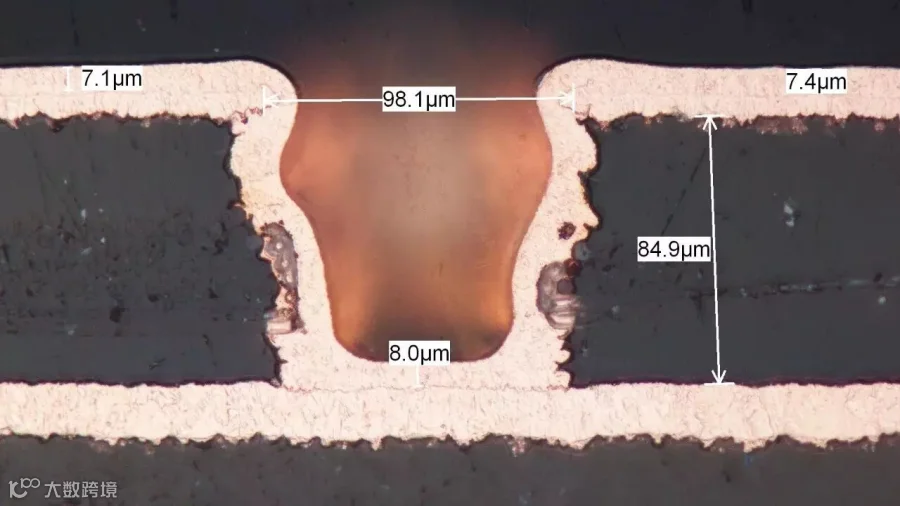
图十三、SOC盲孔闪镀良好2
另外,随着SOC产量的增加,在槽液后期漏填的比例明显上升,我们不得不考虑槽液寿命问题,经过追踪SOC聚合槽的副产物,发现在聚合槽后期,随着副产物的升高,漏填率会升高。因此,建立聚合槽中的副产物的分析方法,规范副产物<1%是一个比较安全的范围。
经过以上的分析与改善,SOC能够形成完美的盲孔电镀,保证生产品质稳定,满足下游客户的要求。我们总结后对SOC过程控制修正如下:

并依些条件批量生产,得到了满意的盲孔填镀品质。

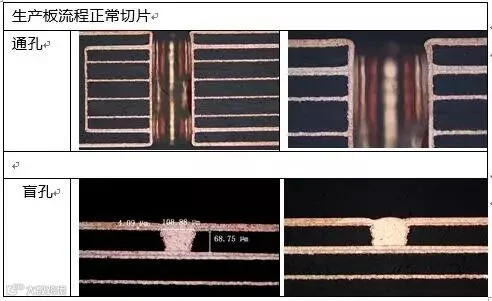
图十四、SOC盲孔通盲孔在客户端的切片
由此可见,采用SOC工艺取代传统的PTH来做微盲孔的导通化是行之有效的选择。
三、结果与展望
通过以上的分析与改善,可以看到单一SOC微盲孔制作不能得到极好的电镀效果,配有闪镀后可以得到理想的盲孔电镀质量。随着国家对环境资源的重视,在落实十三五规划的同时,我们PCB行业也将随着历史的朝流不断采用新型的环保低碳工艺,传统垂直的化学镀铜工艺由于工作环境的不友好,将逐步被水平的SOC等环保工艺所取代;如何快速的跟上社会发展的升级换代,是药水研究开发商们所面临的一个不可避免的挑战,SOC工艺将不断改进,达到理想的盲孔填镀质量。
该论文得到广州市产学研协同创新重大专项“环保型高导电性PCB微孔导通化工艺及关键材料的开发与产业化”(No:201605121851268) 的资助。
参考文献
[1] 肖亮等,选择性有机导电聚合工艺研究,印制电路信息,2013.11
[2] 刘彬云,SOC制程在HDI盲孔金属化中的应用,第十届全国印制电路学术年会2016.10


